1. B. K. Bose, Evaluation of Modern Power Semiconductor Devices and Future Trends of Converters,
IEEE Trans. Ind. Appl. 28(2) (1992) 403ŌĆō413. https://doi.org/10.1109/28.126749
[CROSSREF] 2. C. Buttay, D. Planson, B. Allard, D. Bergogne, P. Bevilacqua, C. Joubert, M. Lazar, C. Martin, H. Morel, D. Tournier, and C.. Raynaud, State of the art of high temperature power electronics,
Mater. Sci. Eng. B:Solid-State Mater. Adv. Technol. 176(4) (2011) 283ŌĆō288. https://doi.org/10.1016/j.mseb.2010.10.003
[CROSSREF] 3. J. Lee, D. Jung, S. Oh, and J. Jung, High Technology and Latest Trends of WBG Power Semiconductors, J. Micro- electron. Packag. Soc. 25(4) (2018) 17ŌĆō23. https://doi.org/10.6117/kmeps.2018.25.4.017
4. T. Ericsen, Future navy application of wide bandgap power semiconductor devices,
Proc. IEEE. 90(6) (2002) 1077ŌĆō1082. https://doi.org/10.1109/JPROC.2002.1021572
[CROSSREF] 5. S. W. Yoon, M. D. Glover, and K. Shiozaki, Nickel-tin transient liquid phase bonding toward high-temperature operational power electronics in electrified vehicles,
IEEE Trans. Power Electron. 28(5) (2013) 2448ŌĆō2456. https://doi.org/10.1109/TPEL.2012.2212211
[CROSSREF] 6. J. W. Xian, S. A. Belyakov, and C. M. Gourlay, Con- trolling Bulk Cu6Sn5 Nucleation in Sn0.7Cu/Cu Joints with Al Micro-alloying,
J. Electron. Mater. 45(1) (2016) 69ŌĆō78. https://doi.org/10.1007/s11664-015-4092-y
[CROSSREF] [PDF] 7. H. Lee, V. Smet, and R. Tummala, A Review of SiC Power Module Packaging Technologies Challenges Advances and Emerging Issues,
IEEE J. Emerg. Sel. Top. Power Electron. 8(1) (2020) 239ŌĆō255. https://doi.org/10.1109/JESTPE.2019.2951801
[CROSSREF] 8. H. A. Mustain, W. D. Brown, and S. S. Ang, Transient liquid phase die attach for high-temperature silicon carbide power devices,
IEEE Trans. Components Packag. Technol. 33(3) (2010) 563ŌĆō570. https://doi.org/10.1109/TCAPT.2010.2046901
[CROSSREF] 9. G. Zeng, S.. McDonald, and K. Nogita, Development of high-temperature solders Review,
Microelectron. Reliab. 52(7) (2012) 1306ŌĆō1322. https://doi.org/10.1016/j.microrel.2012.02.018
[CROSSREF] 10. L. S. Pei, B. Pan, H. Zhang, W. Ng, B. Wu, K. S. Siow, S. Sabne, and M. Tsuriya, High-Temperature Pb-Free Die Attach Material Project Phase 1 :Survey Result,
International Conference on Electronics Packaging (ICEP)Yamagata, Japan. (2017) 51ŌĆō56.
[CROSSREF] 11. H. Zhang, J. Minter, and N. C. Lee, A Brief Review on High-Temperature Pb-Free Die-Attach Materials,
J. Electron. Mater. 48(1) (2019) 201ŌĆō210. https://doi.org/10.1007/s11664-018-6707-6
[CROSSREF] [PDF] 12. W. S. Hong, G. Goo, and U. H. Hwang, Verification Guideline of Pb-free Solder Joint Reliability for Military Electronics,
J. Korean. Weld. Soc. 30(3) (2012) 242ŌĆō248. https://doi.org/10.5781/KWJS.2012.30.3.242
[CROSSREF] 13. M. Ohadi and J. Qi, Thermal Management of Harsh- Environment Electronics,
Twentieth Annual IEEE Semiconduc- tor Thermal Measurement and Management Symposium. San Jose, Ca, USA: (2004) 231ŌĆō240.
[CROSSREF] 14. B. Hu, F. Yang, Y. Peng, H. Ji, S. Yang, M. Yang, and M. Li, Rapid formation of Cu-Cu joints with high shear strength using multiple-flocculated Ag nanoparticle paste,
J. Mater. Sci. Mater. Electron. 30(8) (2019) 8071ŌĆō8079. https://doi.org/10.1007/s10854-019-01129-y
[CROSSREF] [PDF] 15. M. H. Roh, H. Nishikawa, and J. P. Jung, A Review of Ag Paste Bonding for Automotive Power Device Pac- kaging,
J. Microelectron. Packag. Soc. 22(4) (2015) 15ŌĆō23. https://doi.org/10.6117/kmeps.2015.22.4.015
[CROSSREF] [PDF] 16. M.-H. Roh, H. Nishikawa, J. P. Jung, and W. Kim, Trasient Liquid Phase bonding for Power Semiconductor,
J. Microelectron. Packag. Soc. 24(1) (2017) 27ŌĆō34. https://doi.org/10.6117/kmeps.2017.24.1.027
[CROSSREF] [PDF] 17. W. Zhang, J. Chen, Z. Deng, Z. Liu, Q. Huang, W. Guo, and J. Huang, The pressureless sintering of micron silver paste for electrical connections,
J. Alloys Compd. 795(4) (2019) 163ŌĆō167. https://doi.org/10.1016/j.jallcom.2019.04.270
[CROSSREF] 18. K. S. Siow and S. T. Chua, Thermal Ageing Studies of Sintered Micron-Silver (Ag) Joint as a Lead-Free Bonding Material,
Met. Mater. Int. (2019) https://doi.org/10.1007/s12540-019-00394-0
[CROSSREF] [PDF] 19. J. W. Yoon, J. H. Back, and S. B. Jung, Effect of surface finish metallization on mechanical strength of Ag sintered joint,
Microelectron. Eng. 198(7) (2018) 15ŌĆō21. https://doi.org/10.1016/j.mee.2018.06.009
[CROSSREF] 20. G. O. Cook and C. D. Sorensen, Overview of transient liquid phase and partial transient liquid phase bonding,
J. Mater. Sci. 46(16) (2011) 5305ŌĆō5323. https://doi.org/10.1007/s10853-011-5561-1
[CROSSREF] [PDF] 21. M. S. Park, S. L. Gibbons, and R. Arr├│yave, Prediction of processing maps for transient liquid phase diffusion bonding of Cu/Sn/Cu joints in microelectronics packaging,
Microelectron. Reliab. 54(6) (2014) 1401ŌĆō1411. https://doi.org/10.1016/j.microrel.2014.02.023
[CROSSREF] 22. O. Mokhtari, A review:Formation of voids in solder joint during the transient liquid phase bonding process Causes- and solutions,
Microelectron. Reliab. 98(10) (2018) 95ŌĆō105. https://doi.org/10.1016/j.microrel.2019.04.024
[CROSSREF] 23. N. Zhao, Y. Zhong, M. L. Huang, H. T. Ma, and W. Dong, Growth kinetics of Cu
6Sn
5intermetallic compound at liquid-solid interfaces in Cu/Sn/Cu interconnects under temperature gradient,
Sci. Rep. 5(1) (2015) 1ŌĆō12. https://doi.org/10.1038/srep13491
[CROSSREF] [PDF] 24. S. Baek, Y. Park, C. Oh, E. Chun, and N. Kang, Modeling and experimental verification of intermetallic compounds grown by electromigration and thermomigration for Sn-0.7Cu solders,
J. Elctron. Mater. 48(1) (2019) 142ŌĆō151. https://doi.org/10.1007/s11664-018-6786-4
[CROSSREF] [PDF] 25. M. Heo, N. Kang, S. Park, J. Kim, and W. Hong, Kinetics of Intermetallic Compounds Growth Induced by Elec- tromigration of Sn-0.7Cu Solder,
Korean J. Met. Mater. 54(12) (2016) 908ŌĆō915. https://doi.org/10.3365/KJMM.2016.54.12.908
[CROSSREF] 26. J. Feng, C. Hang, Y. Tian, B. Liu, and C. Wang, Growth kinetics of Cu
6Sn
5intermetallic compound in Cu-liquid Sn interfacial reaction enhanced by electric current,
Sci. Rep. 8(1) (2018) 1ŌĆō10. https://doi.org/10.1038/s41598-018-20100-1
[CROSSREF] [PUBMED] [PMC] [PDF] 27. Z. Yin, F. Sun, and M. Guo, The fast formation of Cu- Sn intermetallic compound in Cu/Sn/Cu system by induction heating process,
Mater. Lett. (2018) 215 207ŌĆō2. 10. https://doi.org/10.1016/j.matlet.2017.12.102
[CROSSREF] 28. H. Shao, A. Wu, Y. Bao, Y. Zhao, L. Liu, and G. Zou, Rapid Ag/Sn/Ag transient liquid phase bonding for high-temperature power devices packaging by the assistance of ultrasound,
Ultrason. Sonochem. (2017) 37 561ŌĆō570. https://doi.org/10.1016/j.ultsonch.2017.02.016
[CROSSREF] [PUBMED] 29. Z. L. Li, H. J. Dong, X. G. Song, H. Y. Zhao, J. C. Feng, J. H. Liu, H. Tian, and S. J. Wang, Rapid formation of Ni
3Sn
4joints for die attachment of SiC-based high temperature power devices using ultrasound-induced transient liquid phase bonding process,
Ultrason. So- nochem. (2017) 36 111ŌĆō120. https://doi.org/10.1016/j.ultsonch.2016.12.026
[CROSSREF] [PDF] 30. Y. Bao, A. Wu, H. Shao, Y. Zhao, and G. Zou, Effect of powders on microstructures and mechanical properties for Sn-Ag transient liquid phase bonding in air,
J. Mater. Sci. Mater. Electron. 29(12) (2018) 10246ŌĆō10257. https://doi.org/10.1007/s10854-018-9076-2
[CROSSREF] [PDF] 31. A. Sharif, C. L. Gan, and Z. Chen, Transient liquid phase Ag-based solder technology for high-temperature packaging applications,
J. Alloys Compd. (2014) 587 365ŌĆō368. https://doi.org/10.1016/j.jallcom.2013.10.204
[CROSSREF] 32. F. Yu, H. Liu, C. Hang, H. Chen, and M. Li, Rapid Formation of Full Intermetallic Bondlines for Die Attachment in High-Temperature Power Devices Based on Micro-sized Sn-Coated Ag,
Particles Jom. 71(9) (2019) 3049ŌĆō3056. https://doi.org/10.1007/s11837-019-03544-2
[CROSSREF] [PDF] 33. F. Yu, H. Chen, C. Hang, and M. Li, Fabrication of high-temperature-resistant bondline based on multilayer core-shell hybrid microspheres for power devices,
J. Mater. Sci. Mater. Electron. 30(4) (2019) 3595ŌĆō3603. https://doi.org/10.1007/s10854-018-00637-7
[CROSSREF] [PDF] 34. M. Xiong, L. Zhang, L. Sun, P. He, and W. Long, Effect of CuZnAl particles addition on microstructure of Cu/Sn58Bi/Cu TLP bonding solder joints,
Vacuum. 167(3) (2019) 301ŌĆō306. https://doi.org/10.1016/j.vacuum.2019.06.024
[CROSSREF] 35. S. Sohn, B. Moon, J. Lee, N. Kang, and Y. Moon, Inter- layer Material Design Reducing Transient Liquid Phase Bonding Time,
Electron. Mater. Lett. 16(2) (2020) 106ŌĆō114. https://doi.org/10.1007/s13391-019-00191-2
[CROSSREF] [PDF]
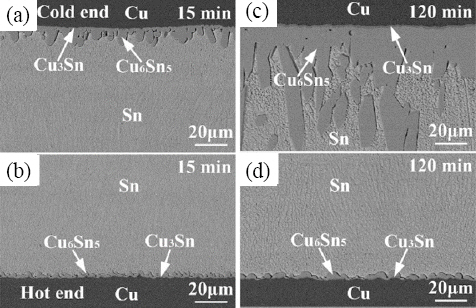

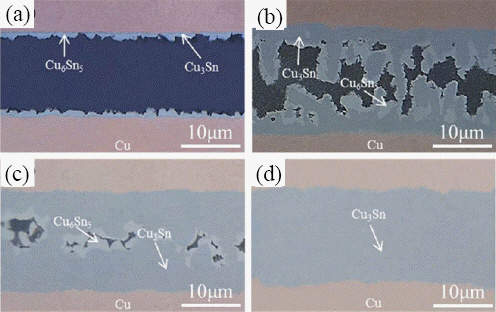
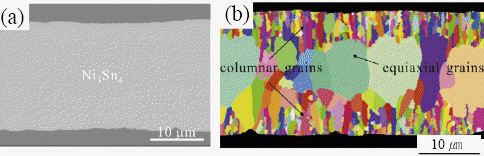
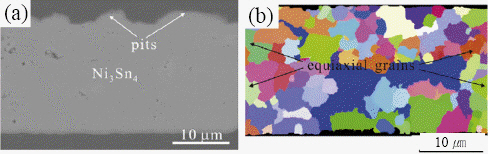
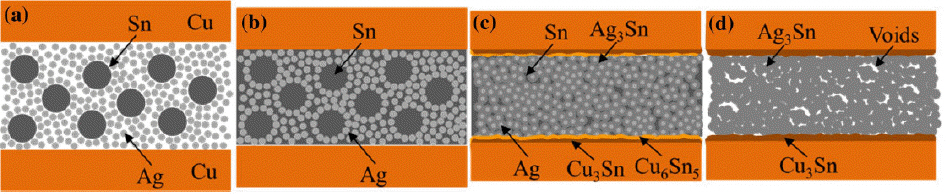
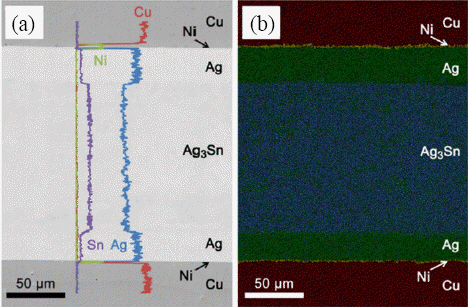






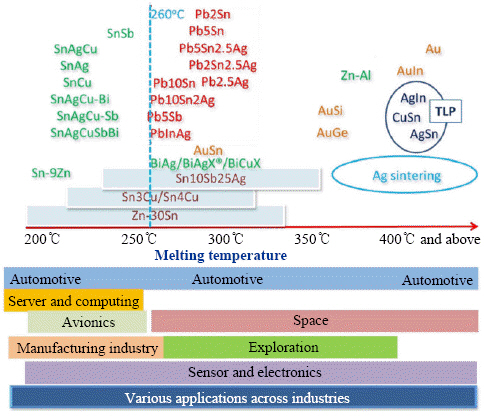
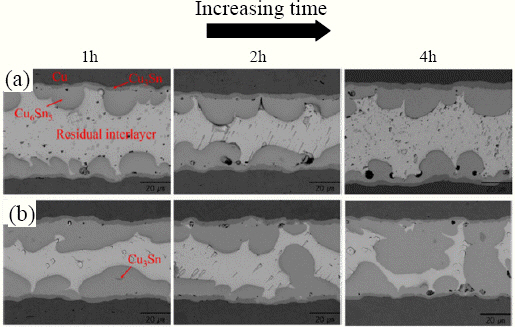
 PDF Links
PDF Links PubReader
PubReader ePub Link
ePub Link Full text via DOI
Full text via DOI Download Citation
Download Citation Print
Print



