| J Weld Join > Volume 35(5); 2017 > Article |
Abstract
In this study, we studied properties of solder joint between chips and a substrate using Pb-free solders of Sn-5Sb (in wt.%), Sn-8Sb and Sn-10Sb solder pastes with various Sb contents for automotive power module. We also compared with Sn-90Pb solder joint used in conventional industry. The conditions of aging test were at 125 ┬░C and 175 ┬░C until 1,000 hours, respectively. The shear strength was measured with the shear speed of 250 ╬╝m/s and the shear height of 100 ╬╝m. After aging time to 1,000 h at 125 and 175┬░C, the shear strengths of the Sn- (5, 8, 10)Sb solder were larger than that of Sn-90Pb solder. The shear strengths increased with Sb contents due to the solution strengthening of Sb and precipitation of SnSb. The total thicknesses of intermetallic compounds (IMCs) were also measured to evaluate effects of Sn contents on thermal behavior of solder joint. After aging test, IMC thicknesses of the Sn-(5, 8, 10) Sb solder was thicker than those of Sn-90Pb solder. IMC thicknesses were increased by increasing Sb contents.
ņ×ÉļÅÖņ░©ņÜ® ņĀäļĀź ļ░śļÅäņ▓┤ļŖö ņĀäļĀź ļ│ĆĒÖś, ļ│ĆņĢĢ, ļČäļ░░ ļō▒ņØä ņłśĒ¢ēĒĢśļŖö ĒĢĄņŗ¼ ļČĆĒÆłņØ┤ļ®░ ņØ╝ļ░ś ļ░śļÅäņ▓┤ņŚÉ ļ╣äĒĢ┤ Ļ│Āļé┤ņĢĢĒÖö, Ļ│ĀņŗĀļó░ņä▒ ļō▒ņØ┤ ņÜöĻĄ¼ļÉśļ®░, ņĀäļÅÖņ░©, ĒĢśņØ┤ļĖīļ”¼ļō£ ņ×ÉļÅÖņ░©, ņĀäĻĖ░ ņ×ÉļÅÖņ░© ļō▒ņØś Ļ░£ļ░£ļĪ£ ĻĘĖ ņłśņÜöĻ░Ć ņ”ØĻ░Ć ņČöņäĖņŚÉ ņ׳ļŗż1). Si ĻĖ░ļ░śņØś ņĀäļĀź ļ░śļÅäņ▓┤ ļ¬©ļōłņØś Ļ▓ĮņÜ░ ņ×ÉļÅÖņ░© ņÜ┤Ē¢ē ņżæ ņåīņ×É ļÅÖņ×æņś©ļÅäļŖö ĒÅēĻĘĀ 150 ┬░C ņĀĢļÅäļĪ£ ņ£ĄņĀÉ 180~230 ┬░C ņĀĢļÅäņØś ņ£ĄņĀÉņØä Ļ░Ćņ¦ĆļŖö PbĻ│ä ņåöļŹö, Sn-Cu-AgĻ│ä ņåöļŹö ļō▒ņØä ņØ┤ņÜ®ĒĢśņŚ¼ ņĀ£ņĪ░ĒĢśĻ│Ā ņ׳ļŗż2,3). Ēśäņ×¼ SiC ĻĖ░ļ░śņØś ņĀäļĀź ļ░śļÅäņ▓┤Ļ░Ć Ļ░£ļ░£ ļÉśĻ│Ā ņ׳ļŖöļŹ░, SiC ĻĖ░ļ░ś ļ░śļÅäņ▓┤ļŖö SiņŚÉ ļ╣äĒĢ┤ ļäōņØĆ ļ░┤ļō£ Ļ░Ł, ļåÆņØĆ ĒīīĻ┤┤ņĀäņĢĢ, ļåÆņØĆ ņŚ┤ņĀäļÅäļÅä, ļ╣ĀļźĖ ĒżĒÖöņĀäņ×ÉņåŹļÅäļź╝ Ļ░¢Ļ│Ā ņ׳ņ¢┤ Ļ│ĀĒÜ©ņ£© ņĀĆņåÉņŗż ņĀäļĀźņåīņ×ÉņŚÉ ņĀüĒĢ®ĒĢśņŚ¼ ņ×ÉļÅÖņ░©ņÜ® ņĀäļĀź ļ░śļÅäņ▓┤ļĪ£ Ļ░üĻ┤æ ļ░øĻ│Ā ņ׳ļŗż4,5). SiC ņåīņ×É ĻĖ░ļ░śņØś ņĀäļĀź ļ░śļÅäņ▓┤ņØś Ļ▓ĮņÜ░ ņåīņ×É ļÅÖņ×æņś©ļÅäļŖö ĒÅēĻĘĀ 200 ┬░C ņØ┤ņāüņØś ņś©ļÅäņŚÉņä£ ĻĄ¼ļÅÖļÉśļ®░, ņł£Ļ░äņĀüņØĖ ļÅÖņ×æņØĆ ņĢĮ 235 ┬░C ņØ┤ņāüņ£╝ļĪ£ ļÅäļŗ¼ĒĢśĻĖ░ ļĢīļ¼ĖņŚÉ ĻĖ░ņĪ┤ Si ĻĖ░ļ░ś ņĀäļĀź ļ░śļÅäņ▓┤ņŚÉ ņé¼ņÜ®ĒĢśļŹś ņåöļŹöļŖö Ļ│Āņś© ņĢłņĀĢņä▒ ļĢīļ¼ĖņŚÉ ņé¼ņÜ®ņØ┤ ņĀ£ĒĢ£ļÉ£ļŗż6,7). ņØ┤ļź╝ ļīĆņ▓┤ ĒĢĀ Ļ│Āņś© ņåöļŹö Ēøäļ│┤ĻĄ░ņ£╝ļĪ£ Au-SnĻ│ä, Sn-ZnĻ│ä, Sn-AlĻ│ä, Sn-SbĻ│ä ļō▒ņØ┤ Ļ▒░ļĪĀ ļÉśĻ│Ā ņ׳ņ£╝ļ®░, ņĀæĒĢ® Ļ│Ąļ▓Ģņ£╝ļĪ£ļŖö TLP ļ│Ėļö® ļ░Å ņŗĀĒä░ļ¦ü ļ│Ėļö®ņŚÉ ļīĆĒĢ£ ņŚ░ĻĄ¼Ļ░Ć ņ¦äĒ¢ē ļÉśĻ│Ā ņ׳ļŗż. ĻĘĖļ¤¼ļéś ZnĻ│ä ĒĢ®ĻĖłņØĆ Ļ░ĢļÅäņÖĆ creep ĒŖ╣ņä▒ ļ░Å ļé┤ņŚ┤Ēö╝ļĪ£ņä▒ņØ┤ ņÜ░ņłśĒĢśĻ│Ā Ļ▓ĮņĀ£ņĀüņØ┤ņ¦Ćļ¦ī, CuņŚÉ ļīĆĒĢ£ ņĀ¢ņØīņä▒ņØ┤ ņóŗņ¦Ć ņĢŖĻ│Ā Ļ│ĄĻ│Ą(void) ļō▒ņØś Ļ▓░ĒĢ© ļ¼ĖņĀ£ļź╝ Ļ░Ćņ¦ĆĻ│Ā ņ׳ņ£╝ļ®░, AlĻ│ä ĒĢ®ĻĖłņØĆ ņé░ĒÖö ĒŖ╣ņä▒ņØ┤ Ļ░ĢĒĢ┤ ņĀ¢ņØīņä▒ņØ┤ ĒÖĢļ│┤ļÉśņ¦Ć ņĢŖļŖö ļ¼ĖņĀ£ļź╝ Ļ░Ćņ¦ĆĻ│Ā ņ׳ļŗż8,9). ļśÉĒĢ£ Bi Ļ│ä ĒĢ®ĻĖłņØĆ ņĘ©ņä▒ ļ░Å ĻĖ░Ļ│äņĀü ĒŖ╣ņä▒ ļ¼ĖņĀ£ļĪ£ ņØĖĒĢ┤ ņé¼ņÜ®ņØ┤ ņĀ£ĒĢ£ļÉśĻ│Ā ņ׳ļŗż10). AuĻ│ä ĒĢ®ĻĖłņØĆ ņŚ┤ņĀüņ£╝ļĪ£ļéś ĻĖ░Ļ│äņĀü ĒŖ╣ņä▒ņØ┤ ņÜ░ņłśĒĢśĻ│Ā, ņÜ░ņłśĒĢ£ Ēö╝ļĪ£ ļ░Å Ēü¼ļ”Į ĒŖ╣ņä▒ņØä Ļ░Ćņ¦Ćņ¦Ćļ¦ī, ņøÉņ×¼ļŻī Ļ░ĆĻ▓®ņ£╝ļĪ£ ņØĖĒĢ┤ ņé░ņŚģņĀüņØĖ ņŗżņÜ®ņä▒ņØ┤ ļ¢©ņ¢┤ņ¦ĆļŖö ļ¼ĖņĀ£ņĀÉņØä Ļ░Ćņ¦ĆĻ│Ā ņ׳ļŗż. ļśÉĒĢ£ TLP (Transient Liquid Phase) ļ│Ėļö®ņØĆ ņåöļŹöļ¦üļ│┤ļŗż Ļ│Āņś©ņŚÉņä£ ņé¼ņÜ® Ļ░ĆļŖźĒĢ£ ņןņĀÉņØ┤ ņ׳ņ¦Ćļ¦ī, ņĘ©ņä▒ ļ░Å ņĀæĒĢ® ņŗ£Ļ░ä ļ░Å ņĢĢļĀź ņĪ░Ļ▒┤ņ£╝ļĪ£ ņØĖĒĢ£ ļ¼ĖņĀ£ļĪ£ ņé¼ņÜ®ņŚÉ ņĀ£ņĢĮņØä Ļ░Ćņ¦ĆĻ│Ā ņ׳ļŗż. ņŗĀĒä░ļ¦ü ļ│Ėļö®ņØĆ Ag ĒÄśņØ┤ņŖżĒŖĖņØś ļåÆņØĆ Ļ░ĆĻ▓® ļ░Å Ļ│Āņś© ļ│Ėļö® ļ░Å ņŗ£Ļ░äņØś ņĀ£ņĢĮņØä Ļ░Ćņ¦ĆĻ│Ā ņ׳ļŗż.
ņØ┤ņŚÉ ļ│Ė ņŚ░ĻĄ¼ņŚÉņä£ļŖö, ņÜ░ņłśĒĢ£ Ēü¼ļ”Į ĒŖ╣ņä▒Ļ│╝ ļåÆņØĆ ĻĖ░Ļ│äņĀü ĒŖ╣ņä▒, ņĀ¢ņØīņä▒ņØ┤ ņ¢æĒśĖĒĢ£ Sn-SbĻ│ä ņåöļŹöļź╝ ņ×ÉļÅÖņ░©ņÜ® ņĀäļĀźļ¬©ļōł ņĀæĒĢ®ņåīņ×¼ņŚÉ ņĀüņÜ® Ēøä ĻĘĖ ĒŖ╣ņä▒ņØä ĒÅēĻ░ĆĒĢśņśĆļŗż11). ĻĖ░Ļ│äņĀü ĒŖ╣ņä▒ ĒÅēĻ░ĆļĪ£ļŖö Ēæ£ļ®┤ņŗżņןņÜ® ļČĆĒÆłĻ│╝ PCB Ēæ£ļ®┤ņ▓śļ”¼ņŚÉ ļö░ļźĖ ņĀæĒĢ®Ļ░ĢļÅä, ĒÖśĻ▓Įļé┤ĻĄ¼ņŗ£ĒŚśņ£╝ļĪ£ļŖö Ļ│Āņś©ņŗ£ĒÜ© ņŗ£ĒŚśņØä ņłśĒ¢ēĒĢśņśĆļŗż. Ļ░üĻ░üņØś ņŗ£ĒŚś Ēøä ĻĖłņåŹĻ░äĒÖöĒĢ®ļ¼╝ Ļ▒░ļÅÖ ļ░Å Ēīīļ®┤ņØä ļČäņäØ ĒÅēĻ░ĆĒĢśņŚ¼ ņ×ÉļÅÖņ░©ņÜ® ņĀäļĀź ļ¬©ļōł ņĀæĒĢ®ņåīņ×¼ļĪ£ņä£ņØś ņĀüĒĢ®ņŚ¼ļČĆļź╝ ĒÅēĻ░ĆĒĢśņśĆļŗż.
ļ│Ė ņŚ░ĻĄ¼ņŚÉņä£ļŖö Sb ĒĢ©ļ¤ēņŚÉ ļö░ļźĖ ņĀæĒĢ®ļČĆņØś ņŚ┤ņĀü ĒŖ╣ņä▒ņØä ļČäņäØĒĢśĻ│Āņ×É ņÜ░ņäĀ Sn-(5, 8, 10)Sb ņåöļŹö ĒÄśņØ┤ņŖżĒŖĖņÖĆ Ni(P) ļ░Å OSP (Organic Solderability Preservative) ļæÉ ņóģļźśņØś Ēæ£ļ®┤ņ▓śļ”¼Ļ░Ć ļÉśņ¢┤ ņ׳ļŖö DBC (Direct Bonded Co- ppoer) ĻĖ░ĒīÉņØä ņØ┤ņÜ®ĒĢśņŚ¼ ņŗ£ĒŚś ņ┐ĀĒÅ░ņØä ņĀ£ņ×æ ĒĢśņśĆļŗż. ņ£äņŚÉ ņ¢ĖĻĖēļÉ£ ņĪ░ņä▒ņØś ņåöļŹö ĒÄśņØ┤ņŖżĒŖĖļź╝ ņé¼ņÜ®ĒĢśņŚ¼ ņØĖņćä Ēøä, ņ¦äĻ│Ą ļ”¼ĒöīļĪ£ņÜ░ļź╝ ņé¼ņÜ®ĒĢśņŚ¼ 2.0├Ś1.2 mm sizeņØś ņ╣®ņØä ņĀæĒĢ®ĒĢśņśĆļŗż. Fig. 1 ņØĆ DBCņÖĆ chipņØś ņĀæĒĢ® ļ¬©ņŗØļÅäņÖĆ ņĀæĒĢ®ļÉ£ ņŗ£ĒÄĖņØä ļéśĒāĆļé┤ņŚłļŗż. ļśÉĒĢ£ ĻĖ░ņĪ┤ņŚÉ ņé░ņŚģĻ│äņŚÉņä£ ļ¦ÄņØ┤ ņé¼ņÜ®ļÉśĻ│Ā ņ׳ļŖö ņĀæĒĢ® ņåīņ×¼ņÖĆ ļ╣äĻĄÉĒĢśĻĖ░ ņ£äĒĢśņŚ¼ Sn-90Pb ņåöļŹö ĒÄśņØ┤ņŖżĒŖĖļź╝ ņØ┤ņÜ®ĒĢśņŚ¼ ļÅÖņØ╝ĒĢśĻ▓ī ņ┐ĀĒÅ░ņØä ņĀ£ņ×æĒĢśņśĆļŗż.
ņ┐ĀĒÅ░ ņĀ£ņ×æņŗ£ ņĀæĒĢ® Ļ│ĄņĀĢ ņżæņŚÉ ļ░£ņāØĒĢśļŖö ļ│┤ņØ┤ļō£ļź╝ ņĄ£ņåīĒÖö ĒĢśĻĖ░ ņ£äĒĢśņŚ¼ Ļ░ü ĒöäļĪ£ĒīīņØ╝ņØś ņÜ®ņ£Ąņś©ļÅäņŚÉņä£ 30ņ┤ł ņ¦äĻ│Ą ĻĄ¼Ļ░äņØä ņäżņĀĢĒĢśņśĆļŗż. ņØ┤ ļĢīņØś ņ¦äĻ│ĄļÅäļŖö 2 mbarļĪ£ ņäżņĀĢĒĢśņśĆņ£╝ļ®░, ņĄ£Ļ│Ā ņś©ļÅäļŖö ņåöļŹö ņĪ░ņä▒ņØś ņ£ĄņĀÉņŚÉ ļö░ļØ╝ ņäżņĀĢĒĢśņśĆļŗż. Table 1 ļ░Å Fig. 2 ļŖö Ļ░ü ņĪ░ņä▒ņØś ņ¦äĻ│Ą ļ”¼ĒöīļĪ£ņÜ░ ĒöäļĪ£ĒīīņØ╝ņØä ļéśĒāĆļé┤ņŚłļŗż.
ņåöļŹö ļé┤ļČĆņÖĆ ņĀæĒĢ®ļČĆņØś ņŚ┤ĒÖö ĒŖ╣ņä▒ ļ░Å ĒÖöĒĢ®ļ¼╝ ņä▒ņןĻ▒░ļÅÖņŚÉ ļö░ļźĖ ņĀæĒĢ®ļČĆņØś ĻĖ░Ļ│äņĀü ĒŖ╣ņä▒ ĒÅēĻ░Ćļź╝ ņ£äĒĢ┤ Ļ│Āņś©ņŗ£ĒÜ© ņŗ£ĒŚśņØä ņ¦äĒ¢ēĒĢśņśĆļŗż. ņĀæĒĢ®ļÉ£ ņŗ£ĒŚśņ┐ĀĒÅ░ņØĆ 125, 175 ┬░C ņŚÉņØ┤ņ¦Ģ ņ▒öļ▓äņŚÉņä£ 0, 100, 300, 500, 700, 1,000 ņŗ£Ļ░ä ļÅÖņĢł ņŗ£ĒÜ©ņ▓śļ”¼ ĒĢśņśĆļŗż,
Ļ│Āņś©ņŗ£ĒÜ© ņŗ£Ļ░äņŚÉ ļö░ļźĖ ņĀäļŗ©Ļ░ĢļÅä ļ│ĆĒÖöļź╝ ņĖĪņĀĢĒĢśĻĖ░ ņ£äĒĢ┤ 100 Kg load cellņØä ņןņ░®ĒĢ£ ņĀæĒĢ®Ļ░ĢļÅä ņŗ£ĒŚśĻĖ░(DAGE- BT4000)ļź╝ ņé¼ņÜ®ĒĢśņśĆļŗż. ļåÆņØ┤ļŖö 100 ╬╝mņŚÉņä£ 250 ╬╝m/s ņåŹļÅäļĪ£ ņĀäļŗ©ņŗ£ĒŚśņØä ņ¦äĒ¢ēĒĢśņśĆņ£╝ļ®░, 20 ĒÜī ļ░śļ│Ąņŗ£ĒŚś Ēøä ĒÅēĻĘĀņØä ļÅäņČ£ĒĢśņśĆļŗż.
Ļ│Āņś©ņŗ£ĒÜ© ņŗ£Ļ░äņŚÉ ļö░ļźĖ ĻĖłņåŹĻ░ä ĒÖöĒĢ®ļ¼╝Ļ│╝ ļ»ĖņäĖĻĄ¼ņĪ░ņØś ļ│ĆĒÖöļź╝ Ļ┤Ćņ░░ĒĢśĻĖ░ ņ£äĒĢ┤ņä£ ņŗ£ĒÄĖņØä ņŚÉĒÅŁņŗ£ ņłśņ¦ĆļĪ£ ļ¦łņÜ┤Ēīģ ĒĢśņśĆļŗż. ĻĘĖ Ēøä, ļŗ©ļ®┤ņØä ņĀłļŗ©ĒĢśņŚ¼ ņŚ░ļ¦łņ¦ĆņÖĆ ņĢīļŻ©ļ»Ėļéś ĒīīņÜ░ļŹöļź╝ ņé¼ņÜ®ĒĢśņŚ¼ ĻĖ░Ļ│äņĀü ņŚ░ļ¦łļź╝ ņŗżņŗ£ĒĢśņśĆļŗż. ņŚ░ļ¦łļÉ£ ņŗ£ĒÄĖņØĆ ņŻ╝ņé¼ņĀäņ×ÉĒśäļ»ĖĻ▓Į(FE-SEM)ņØä ņé¼ņÜ®ĒĢśņŚ¼ ņŗ£ĒÜ©ņ▓śļ”¼ ņŗ£Ļ░äņŚÉ ļö░ļźĖ ļ»ĖņäĖņĪ░ņ¦üĻ│╝ ĻĖłņåŹĻ░ä ĒÖöĒĢ®ļ¼╝ņØś ņä▒ņןĻ▒░ļÅÖņØä ļ╣äĻĄÉ Ļ┤Ćņ░░ĒĢśņśĆļŗż.
ņŗ£ĒÜ©ņ▓śļ”¼ ņŗ£Ļ░ä ļ│ĆĒÖöņŚÉ ļö░ļźĖ ĻĖłņåŹĻ░ä ĒÖöĒĢ®ļ¼╝ Ēü¼ĻĖ░ļź╝ ļ╣äĻĄÉĒĢśĻĖ░ ņ£äĒĢśņŚ¼ ņåöļŹöļź╝ ņŚÉņ╣ŁĒĢśņśĆļŗż. Cu6Sn5 IMCļŖö ņŻ╝ņé¼ņĀäņ×ÉĒśäļ»ĖĻ▓ĮņØä ņé¼ņÜ®ĒĢśņŚ¼ ņŗ£ĒÜ©ņ▓śļ”¼ ņŗ£Ļ░äņŚÉ ļö░ļźĖ ĻĖłņåŹĻ░ä ĒÖöĒĢ®ļ¼╝ņØś Ēü¼ĻĖ░ļź╝ ļ╣äĻĄÉ Ļ┤Ćņ░░ĒĢśņśĆļŗż. ĻĖłņåŹĻ░ä ĒÖöĒĢ®ļ¼╝ņØś Ēü¼ĻĖ░ļŖö ASTM standard E112 ļ░®ļ▓ĢņØä ņØ┤ņÜ®ĒĢśņŚ¼ ņĖĪņĀĢĒĢśņśĆļŗż.
Fig. 3 ņØĆ 125 ┬░C Ļ│Āņś©ņŗ£ĒÜ© ņŗ£ĒŚś Ēøä ņŗ£Ļ░äņŚÉ ļö░ļźĖ ņĀæĒĢ®Ļ░ĢļÅäļź╝ ļéśĒāĆļéĖ ĻĘĖļלĒöäņØ┤ļŗż. ņ┤łĻĖ░ ļ░Å Ļ│Āņś©ņŗ£ĒÜ© ņŗ£ĒŚś Ēøä ņĀæĒĢ®Ļ░ĢļÅäļŖö SbĻ░Ć ņ▓©Ļ░ĆļÉ£ ņåöļŹöĻ░Ć ĻĖ░ņĪ┤ņŚÉ ļ¦ÄņØ┤ ņé¼ņÜ®ļÉśĻ│Ā ņ׳ļŖö Sn-90Pb ņåöļŹö ņĀæĒĢ®ļČĆņŚÉ ļ╣äĒĢśņŚ¼ ļåÆņØĆ Ļ░ÆņØä ļéśĒāĆļé┤ņŚłļŗż. ĒĢ£ĒÄĖ SbĻ░Ć ņ▓©Ļ░ĆļÉśļŖö Ļ▓ĮņÜ░ SbņØś ņ▓©Ļ░Ćļ¤ēņØ┤ ņ”ØĻ░ĆĒĢĀņłśļĪØ ļåÆņØĆ Ļ░ĢļÅä Ļ░ÆņØä ļéśĒāĆļé┤ņŚłļŗż. Fig. 4 ļŖö 175 ┬░C Ļ│Āņś©ņŗ£ĒÜ© ņŗ£ĒŚś Ēøä ņŗ£Ļ░äņŚÉ ļö░ļźĖ ņĀæĒĢ®Ļ░ĢļÅäļź╝ ļéśĒāĆļéĖ ĻĘĖļלĒöäņØ┤ļŗż. 175 ┬░CņŚÉņä£ļÅä ļ¦łņ░¼Ļ░Ćņ¦ĆļĪ£ ņŗ£ĒÜ©ņ▓śļ”¼ņŚÉ Ļ┤ĆĻ│ä ņŚåņØ┤ SbĻ░Ć ņ▓©Ļ░ĆļÉśļŖö Ļ▓ĮņÜ░ņŚÉ ļåÆņØĆ Ļ░ĢļÅä Ļ░ÆņØä ļéśĒāĆļé┤ņŚłļŗż. ņĀæĒĢ®Ļ░ĢļÅäņØś Ļ▓ĮņÜ░ Ēæ£ļ®┤ņ▓śļ”¼ņØś ļ░®ļ▓Ģ ļ░Å ņŗ£ĒÜ©ņ▓śļ”¼ ņś©ļÅä, ņŗ£ĒÜ©ņ▓śļ”¼ ņŗ£Ļ░äņŚÉ Ļ┤ĆĻ│ä ņŚåņØ┤ SbĻ░Ć ņ▓©Ļ░ĆļÉśļŖö Ļ▓ĮņÜ░ņŚÉ ļåÆņØĆ Ļ░ĢļÅä Ļ░ÆņØä ļéśĒāĆļé┤ņŚłļŗż.
ņĀäļŗ©Ļ░ĢļÅä ņŗ£ĒŚś Ēøä ĒīīĻ┤┤ ļ¬©ļō£ļź╝ Ļ┤Ćņ░░ĒĢśĻĖ░ ņ£äĒĢ┤ SEMņØä ņØ┤ņÜ®ĒĢśņŚ¼ Ēīīļŗ©ļ®┤ņØä Ļ┤Ćņ░░ĒĢśņśĆļŗż. Fig. 5 ļŖö ņä£ļĪ£ ļŗżļźĖ ņŗ£ĒÜ© ņś©ļÅäņÖĆ ņŗ£Ļ░äņŚÉņä£ Ēīīļŗ©ļ®┤ņØä Ļ┤Ćņ░░ĒĢ£ SEM ņØ┤ļ»Ėņ¦ĆņØ┤ļŗż, ļ¬©ļōĀ ņĪ░Ļ▒┤ņŚÉņä£ ņåöļŹö ļé┤ļČĆļĪ£ Ēīīļŗ©ņØ┤ ļ░£ņāØ ĒĢśņśĆņ£╝ļ®░, Ēīīļŗ©ļ®┤ņØĆ ļ¬©ļæÉ ņŚ░ņä▒ ĒīīĻ┤┤ļź╝ ļ│┤ņśĆļŗż12,13).
Fig. 6 ļŖö 125 ┬░C ņŚÉņä£ ņŗ£ĒÜ© ņ▓śļ”¼ ņŗ£Ļ░ä ļ│ĆĒÖöņŚÉ ļö░ļźĖ Sn- (5, 8, 10)Sb, Sn-90Pb ņåöļŹöņÖĆ Ni(P), OSP Cu DBC ņŗ£ĒŚś ņ┐ĀĒÅ░ ņé¼ņØ┤ņØś IMC ļ│ĆĒÖöļź╝ ļéśĒāĆļéĖ ĻĘĖļ”╝ņØ┤ļŗż. Fig. 6 (a) ņŚÉņä£ ņåöļŹö ļ¬©ļæÉ Ni3Sn4 IMC ļ░Å Ni3P IMC ņĖĄņØ┤ Ļ┤Ćņ░░ ļÉśņŚłņ£╝ļ®░ Sn-90Pb ņåöļŹöļŖö Ļ│Āņś©ņŗ£ĒÜ© Ēøä Ni3Sn4 IMC ņØś ļæÉĻ╗śĻ░Ć ņåīĒÅŁ ņ”ØĻ░ĆĒĢśņśĆļŗż. Sn-(5, 8, 10)Sb ņåöļŹöņØś Ļ▓ĮņÜ░ Ļ│Āņś©ņŗ£ĒÜ© ņŗ£Ļ░äņŚÉ ļö░ļØ╝ Ni3Sn4 IMC ņØś ļæÉĻ╗śĻ░Ć ņ”ØĻ░Ć ĒĢśņśĆļŗż. Fig. 6 (b) ņŚÉņä£ļŖö ņ┤łĻĖ░ņŚÉļŖö Cu6Sn5 IMCĻ░Ć ņāØņä▒ ļÉśņŚłļŗż. Sn-(5, 8, 10)Sb ņåöļŹöņØś Ļ▓ĮņÜ░ 100 ņŗ£Ļ░ä Ēøä Cu6Sn5 ņÖĆ OSP Cu DBC ņé¼ņØ┤ņŚÉņä£ ņ¢ćņØĆ Cu3Sn IMC Ļ░Ć Ļ┤Ćņ░░ļÉśņŚłļŗż. Cu3Sn IMCļŖö Sn-90PbņŚÉņä£ Ļ░Ćņן ļæÉĻ╗ŹĻ▓ī ņä▒ņןĒĢśņśĆņ£╝ļ®░, Sn-(5, 8, 10)Sb ņåöļŹöņŚÉņä£ļŖö SbņØś ĒĢ©ļ¤ēņØ┤ ņ”ØĻ░ĆĒĢ©ņŚÉ ļö░ļØ╝ ņåīĒÅŁ ļåÆĻ▓ī ņĖĪņĀĢ ļÉśņŚłļŗż. Fig. 7 ņØĆ Ļ│Āņś©ņŗ£ĒÜ© ņŗ£Ļ░äņŚÉ ļö░ļźĖ IMCņØś ļ│ĆĒÖöļź╝ ļéśĒāĆļéĖ ĻĘĖļלĒöäņØ┤ļŗż. ļæÉ Ēæ£ļ®┤ ņ▓śļ”¼ ļÉ£ DBC ļ¬©ļæÉņŚÉņä£ ņ┤Ø IMC ļæÉĻ╗śļŖö SbņØś ĒĢ©ļ¤ēņØ┤ ņ”ØĻ░ĆĒĢ©ņŚÉ ļö░ļØ╝ ņ┤Ø IMC ļæÉĻ╗śĻ░Ć ņ”ØĻ░Ć ļÉśņŚłņ£╝ļ®░ Sn-90Pb ņåöļŹöņŚÉņä£ Ļ░Ćņן ņĀüņØĆ IMCĻ░Ć Ļ┤Ćņ░░ļÉśņŚłļŗż. Ni(P) DBCņÖĆ Sn-90Pb ņåöļŹö ņé¼ņØ┤ņØś IMC ņä▒ņןņØ┤ ņĀüņØĆ ņØ┤ņ£ĀļŖö ļ░śņØæĒĢĀ SnņØś ĒĢ©ļ¤ēņØ┤ ņĀüĻ│Ā, ļśÉĒĢ£ Ni3Sn4 IMCņØś ņä▒ņן ņŚÉļäłņ¦ĆĻ░Ć ņĀüņ¢┤ ņä▒ņןņØ┤ Ļ▒░ņØś ņØ╝ņ¢┤ļéśņ¦Ć ņĢŖņØĆ Ļ▓āņ£╝ļĪ£ ņé¼ļŻīļÉ£ļŗż.
Fig. 8 ņØĆ 175 ┬░C ņŚÉņä£ ņŗ£ĒÜ© ņ▓śļ”¼ ņŗ£Ļ░ä ļ│ĆĒÖöņŚÉ ļö░ļźĖ Sn-(5, 8, 10)Sb, Sn-90Pb ņåöļŹöņÖĆ Ni(P), OSP Cu DBC ņŗ£ĒŚś ņ┐ĀĒÅ░ ņé¼ņØ┤ņØś IMC ļ│ĆĒÖöļź╝ ļéśĒāĆļéĖ ĻĘĖļ”╝ņØ┤ļŗż. Fig. 8 (a) ņŚÉņä£ ņåöļŹö ļ¬©ļæÉ Ni3Sn4 IMC ļ░Å Ni3P IMC ņĖĄņØ┤ Ļ┤Ćņ░░ ļÉśņŚłņ£╝ļ®░ Sn-90Pb ņåöļŹöļŖö Ļ│Āņś©ņŗ£ĒÜ© Ēøä Ni3Sn4 IMC ņØś ļæÉĻ╗śĻ░Ć ņåīĒÅŁ ņ”ØĻ░ĆĒĢśņśĆļŗż. Sn-(5, 8, 10)Sb ņåöļŹöņØś Ļ▓ĮņÜ░ Ļ│Āņś©ņŗ£ĒÜ© ņŗ£Ļ░äņŚÉ ļö░ļØ╝ Ni3Sn4 IMC ņØś ļæÉĻ╗śĻ░Ć ņ”ØĻ░Ć ĒĢśņśĆļŗż. Fig. 8 (b) ņŚÉņä£ ņ┤łĻĖ░ņŚÉļŖö Cu6Sn5 IMCĻ░Ć ņāØņä▒ ļÉśņŚłļŗż. Sn-(5, 8, 10)Sb ņåöļŹöņØś Ļ▓ĮņÜ░ 100 ņŗ£Ļ░ä Ēøä Cu6Sn5 ņÖĆ OSP Cu DBC ņé¼ņØ┤ņŚÉņä£ ņ¢ćņØĆ Cu3Sn IMC Ļ░Ć Ļ┤Ćņ░░ļÉśņŚłļŗż. Cu3Sn IMCļŖö Sn-90PbņŚÉņä£ Ļ░Ćņן ļæÉĻ╗ŹĻ▓ī ņä▒ņןĒĢśņśĆņ£╝ļ®░, Sn- (5, 8, 10)Sb ņåöļŹöņŚÉņä£ļŖö Ēü░ ņ£ĀņØśņ░©ļź╝ ļ│┤ņØ┤ņ¦Ć ņĢŖņĢśļŗż. OSP Cu ņÖĆ Sn-90PbņŚÉņä£ Cu3Sn IMCĻ░Ć Ļ░Ćņן ļ¦ÄņØ┤ ņä▒ņןĒĢ£ ņØ┤ņ£ĀļŖö ņåöļŹö ļé┤ļČĆņØś Sn ĒĢ©ļ¤ēņØ┤ ņĀüĻ│Ā, SnņØś ĒÖĢņé░ņåŹļÅäĻ░Ć ļé«ņĢä Cu6Sn5 IMCņØś ņä▒ņןņØ┤ ņ¢┤ļĀżņøī Cu3Sn IMCĻ░Ć ļ¦ÄņØ┤ ņä▒ņן ĒĢ£ Ļ▓āņ£╝ļĪ£ ņé¼ļŻīļÉ£ļŗż. Fig. 8 ļŖö Ļ│Āņś©ņŗ£ĒÜ© ņŗ£Ļ░äņŚÉ ļö░ļźĖ IMCņØś ļ│ĆĒÖöļź╝ ļéśĒāĆļéĖ ĻĘĖļלĒöäņØ┤ļŗż. ļæÉ Ēæ£ļ®┤ ņ▓śļ”¼ ļÉ£ DBC ļ¬©ļæÉņŚÉņä£ ņ┤Ø IMC ļæÉĻ╗śļŖö SbņØś ĒĢ©ļ¤ēņØ┤ ņ”ØĻ░ĆĒĢ©ņŚÉ ļö░ļØ╝ ņ┤Ø IMC ļæÉĻ╗śĻ░Ć ņ”ØĻ░Ć ļÉśņŚłņ£╝ļ®░ Sn-90Pb ņåöļŹöņŚÉņä£ Ļ░Ćņן ņĀüņØĆ IMCĻ░Ć Ļ┤Ćņ░░ļÉśņŚłļŗż. ņŗ£ĒÜ©ņ▓śļ”¼ ņś©ļÅä, ņåöļŹö ņĪ░ņä▒ņŚÉ ņāüĻ┤ĆņŚåņØ┤ OSP Cu ņŚÉ ļ╣äĒĢ┤ Ni(P) ņāśĒöīņØś IMC ņä▒ņןņØ┤ ņĀüņØĆ ņØ┤ņ£ĀļŖö Cu6Sn5 IMCņŚÉ ļ╣äĒĢ┤ Ni3Sn4 IMCņØś ĒÖĢņé░ņåŹļÅäĻ░Ć ņāüļīĆņĀüņ£╝ļĪ£ ļŖÉļ”¼ĻĖ░ ļĢīļ¼Ėņ£╝ļĪ£ ņé¼ļŻīļÉ£ļŗż14).
Fig. 10ņÖĆ 11ņŚÉ Ļ│Āņś©ņŗ£ĒÜ© ņś©ļÅä ļ░Å ņŗ£Ļ░ä ņĪ░Ļ▒┤ņŚÉ ļö░ļźĖ ĻĖłņåŹĻ░ä ĒÖöĒĢ®ļ¼╝ņØś Ļ▓░ņĀĢļ”Į Ēü¼ĻĖ░ ļ│ĆĒÖöļź╝ ļéśĒāĆļé┤ņŚłļŗż. ĻĖłņåŹĻ░ä ĒÖöĒĢ®ļ¼╝ņØś Ļ▓░ņĀĢļ”Į Ēü¼ĻĖ░ļŖö ņŗ£Ļ░äņØ┤ Ļ▓ĮĻ│╝ĒĢ©ņŚÉ ļö░ļØ╝ ņä▒ņןĒĢ©ņØä ĒÖĢņØĖ ĒĢĀ ņłś ņ׳ņŚłļŗż. Ļ│Āņś©ņŗ£ĒÜ© ņĪ░Ļ▒┤ņŚÉ ļö░ļźĖ Ļ▓░ņĀĢļ”ĮņØś Ēü¼ĻĖ░ļŖö Sn-5Sb ņåöļŹöĻ░Ć Ļ░Ćņן ņ╗Ėņ£╝ļ®░, SbņØś ĒĢ©ļ¤ēņØ┤ ņ”ØĻ░ĆĒĢĀņłśļĪØ Ļ▓░ņĀĢļ”Į Ēü¼ĻĖ░ļŖö ņ×æĻ▓ī ļéśĒāĆļé¼ļŗż. ĻĖ░ņĪ┤ņØś ņŚ░ĻĄ¼ņŚÉ ļö░ļź┤ļ®┤ Sn-xAg-0.5Cu ĒĢ®ĻĖłĻ│äņØś ņŗżĒŚśņŚÉņä£ AgņØś ņ▓©Ļ░ĆĻ░Ć Cu6Sn5ņØś Ļ▓░ņĀĢļ”Į ņä▒ņןņØä ņ¢ĄņĀ£ĒĢśļ®░, Ļ▓░ņĀĢļ”ĮņØ┤ ņ×æņĢäņ¦Ćļ®┤ Cu6Sn5ņØś ņä▒ņןņØ┤ ļ╣©ļØ╝ņ¦ĆĻ│Ā, Cu3Sn IMCņØś ņä▒ņןņØä ņ¢ĄņĀ£ ĒĢśļ®░, ņØ┤ļŖö Ļ│Āņ▓┤ ņāüĒā£ ļ░śņØæ ĒĢśņŚÉ ĻĖłņåŹņøÉņ×ÉņØś ĒÖĢņé░ņØĆ ņ×ģņ×É Ļ▓ĮĻ│äņÖĆ Ļ▓░ĒĢ©ņŚÉ ņØśĒĢ┤ Ļ░ĆņåŹļÉśļ®░, Ļ▓░Ļ│╝ņĀüņ£╝ļĪ£ ļ╣ĀļźĖ ĒÖĢņé░ Ļ▓ĮļĪ£ ļśÉļŖö ņ▒äļäÉ ņŚŁĒĢĀņØä ĒĢ£ļŗżĻ│Ā ļ│┤Ļ│ĀļÉśĻ│Ā ņ׳ļŗż15).
ļö░ļØ╝ņä£ Sn-SbĻ│ä ņåöļŹöļŖö SbĒĢ©ļ¤ē ņ”ØĻ░ĆņŚÉ ļö░ļźĖ SnSbĒÖöĒĢ®ļ¼╝ņØś ĒĢĄ ņāØņä▒ņØ┤ ņ”ØĻ░ĆĒĢśņŚ¼, Cu6Sn5 ņØś Ļ▓░ņĀĢļ”Į ņä▒ņןņØ┤ ņ¢ĄņĀ£ ļÉśļŖö Ļ▓āņ£╝ļĪ£ ņé¼ļŻīļÉ£ļŗż.
ņĢ×ņä£ Fig. 3 Ļ│╝ Fig. 4 ņØś ņĀäļŗ© Ļ░ĢļÅäņØś Ļ▓░Ļ│╝ ĻĖ░ĒīÉņØś Ēæ£ļ®┤ņ▓śļ”¼ ļ░Å ņŗ£ĒÜ©ņ▓śļ”¼ ņś©ļÅäņŚÉ ņāüĻ┤Ć ņŚåņØ┤ SbņØś ĒĢ©ļ¤ēņØ┤ ņ”ØĻ░Ć ĒĢĀņłśļĪØ ļåÆņØĆ Ļ░ĢļÅä Ļ░ÆņØä ļéśĒāĆļé┤ļŖö Ļ▓āņØä ĒÖĢņØĖ ĒĢĀ ņłś ņ׳ņŚłļŗż. ņĀäļŗ© ņŗ£ĒŚś Ēøä Fig. 5ņØś Ēīīļŗ©ļ®┤ņØś ļČäņäØ Ļ▓░Ļ│╝ļź╝ ļ│┤ļ®┤ ņåöļŹö ļé┤ļČĆņØś ņŚ░ņä▒ ĒīīĻ┤┤Ļ░Ć ņÜ░ņäĖĒĢ©ņØä ĒÖĢņØĖ ĒĢĀ ņłś ņ׳ņŚłļŗż. ņØ┤ļŖö ļ│Ė ņŚ░ĻĄ¼ņØś ņĀäļŗ© ņŗ£ĒŚś ņĪ░Ļ▒┤ņŚÉņä£ļŖö IMCņØś ņśüĒ¢ź ļ│┤ļŗżļŖö ņåöļŹö ļé┤ļČĆņØś ĒŖ╣ņä▒ņŚÉ ĻĖ░ņØĖ ĒĢ£ Ļ▓āņ£╝ļĪ£ ņé¼ļŻīļÉśņŚłļŗż. ļö░ļØ╝ņä£ Fig. 12ņŚÉņä£ņÖĆ Ļ░ÖņØ┤ ĻĖ░ĒīÉ Ēæ£ļ®┤ņ▓śļ”¼ ļ░Å Ļ│Āņś©ņŗ£ĒÜ© ņś©ļÅä ļ░Å ņĪ░Ļ▒┤ņŚÉ ļö░ļźĖ ņåöļŹö ļé┤ļČĆņØś SEM mapping ĻĖ░ļ▓ĢņØä ņØ┤ņÜ®ĒĢśņŚ¼ ņåöļŹö ļé┤ļČĆņØś ņä▒ļČä ļČäĒżļź╝ ņé┤ĒÄ┤ ļ│┤ņĢśļŗż. SEM mapping ļČäņäØ Ļ▓░Ļ│╝ Fig. 12ņŚÉņä£ņÖĆ Ļ░ÖņØ┤ Ni(P)ņÖĆ OSP Cu Ēæ£ļ®┤ņ▓śļ”¼ ļÉ£ DBC ļ¬©ļæÉ SbņØś ĒĢ©ļ¤ēņØ┤ ņ”ØĻ░ĆĒĢĀņłśļĪØ SnSb ĒÖöĒĢ®ļ¼╝ņØś ņāØņä▒ņØ┤ ļ¦ÄņØĆ Ļ▓āņ£╝ļĪ£ ļéśĒāĆļé¼ļŗż. ļśÉĒĢ£, Ļ│Āņś©ņŗ£ĒÜ©ņŗ£Ļ░äņØ┤ Ļ▓ĮĻ│╝ĒĢ©ņŚÉ ļö░ļØ╝ SnSb ĒÖöĒĢ®ļ¼╝ņØ┤ ņä▒ņןĒĢ©ņØä ĒÖĢņØĖĒĢĀ ņłś ņ׳ņŚłļŗż. ņØ┤ļŖö ņåöļŹö ļé┤ļČĆņŚÉ ĒśĢņä▒ļÉ£ SnSb ĒÖöĒĢ®ļ¼╝ņØ┤ ņĀäļŗ© Ļ░ĢļÅäņŚÉ ņśüĒ¢źņØä ļ»Ėņ╣£ļŗżĻ│Ā ņé¼ļŻīļÉ£ļŗż. Ļ▓░ĻĄŁ Sb ĒĢ©ļ¤ēņØ┤ ņ”ØĻ░ĆĒĢĀņłśļĪØ ņĀäļŗ©Ļ░ĢļÅäĻ░Ć ļåÆĻ▓ī ļéśĒāĆļé¼ļŖöļŹ░, ņØ┤ļŖö SnSb ĒÖöĒĢ®ļ¼╝ņØś ņāØņä▒ ļ░Å ņä▒ņןņ£╝ļĪ£ ņØĖĒĢ£ ņäØņČ£ Ļ░ĢĒÖö ĒÜ©Ļ│╝ļĪ£ ņé¼ļŻīļÉ£ļŗż16).
ļ│Ė ņŚ░ĻĄ¼ņŚÉņä£ļŖö ņ×ÉļÅÖņ░© ņĀäļĀź ļ░śļÅäņ▓┤ ļ¬©ļōłņŚÉ ņĀüņÜ® Ļ░ĆļŖź ĒĢ£ Sn-(5, 8, 10)Sb ņåöļŹöņÖĆ Sn-90Pb ņåöļŹöļź╝ Ļ│Āņś©ņŗ£ĒÜ©ņŗ£Ļ░äņŚÉ ļö░ļźĖ ņĀæĒĢ®Ļ░ĢļÅä ļ░Å IMC ņĖĄņØś ļæÉĻ╗ś ļ│ĆĒÖöļź╝ Ļ┤Ćņ░░ĒĢśņśĆļŗż. Ļ░ü ņŗżĒŚśņØś Ļ▓░Ļ│╝ļź╝ ĒåĄĒĢ┤ ļŗżņØīĻ│╝ Ļ░ÖņØĆ Ļ▓░ļĪĀņØä ņ¢╗ņŚłļŗż.
1) 125 ┬░C, 175 ┬░C Ļ│Āņś©ņŗ£ĒÜ© ņŗ£ĒŚś Ēøä Ni-P, OSP Cu Ēæ£ļ®┤ņ▓śļ”¼ ļÉ£ DBCņØś ņĀæĒĢ®Ļ░ĢļÅä ņĖĪņĀĢ Ļ▓░Ļ│╝, SbĻ░Ć ņ▓©Ļ░ĆļÉ£ Ļ▓ĮņÜ░ Sn-90PbņŚÉ ļ╣äĒĢśņŚ¼ ļåÆņØĆ Ļ░ĢļÅä Ļ░ÆņØä ļéśĒāĆļé┤ņŚłņ£╝ļ®░ SbņØś ņ▓©Ļ░Ćļ¤ēņØ┤ ņ”ØĻ░ĆĒĢĀņłśļĪØ ļåÆņØĆ Ļ░ĢļÅä Ļ░ÆņØä ļéśĒāĆļé┤ņŚłļŗż. Sb ĒĢ©ļ¤ēņØ┤ ņ”ØĻ░Ć ĒĢĀņłśļĪØ ņĀæĒĢ®Ļ░ĢļÅäĻ░Ć ņ”ØĻ░ĆĒĢśļŖö ņØ┤ņ£ĀļŖö SbņØś Ļ│ĀņÜ®ņ£╝ļĪ£ ņØĖĒĢ£ Ļ│ĀņÜ®Ļ░ĢĒÖöņØś ĒÜ©Ļ│╝ ļ░Å SnSb ĒÖöĒĢ®ļ¼╝ņØś ņäØņČ£ļĪ£ ņØĖĒĢ£ ņäØņČ£ Ļ░ĢĒÖö ĒÜ©Ļ│╝ļĪ£ ņé¼ļŻīļÉ£ļŗż.
2) 125 ┬░C, 175 ┬░C Ļ│Āņś©ņŗ£ĒÜ© ņŗ£ĒŚś Ēøä IMC ļæÉĻ╗ś ņĖĪņĀĢ Ļ▓░Ļ│╝, Sn-90PbņØś ņ┤Ø IMCņØś ļæÉĻ╗śļŖö Ļ░Ćņן ņ×æĻ▓ī ņĖĪņĀĢ ļÉśņŚłņ£╝ļ®░, SbņØś ĒĢ©ļ¤ēņØ┤ ņ”ØĻ░ĆĒĢ©ņŚÉ ļö░ļØ╝ ņ┤Ø IMCņØś ļæÉĻ╗śĻ░Ć ņ”ØĻ░ĆļÉśņŚłļŗż. SbĒĢ©ļ¤ēņØś ņ”ØĻ░ĆņŚÉ ļö░ļźĖ ĒÖĢņé░ņåŹļÅäĻ░Ć ņ”ØĻ░ĆļÉśņ¢┤, ņ┤Ø IMC ļæÉĻ╗śņØś ņä▒ņןņØ┤ ļ¦ÄņØĆ Ļ▓āņ£╝ļĪ£ ņé¼ļŻīļÉ£ļŗż. ļśÉĒĢ£, OSP Cu ņŚÉ ļ╣äĒĢ┤ Ni-P ņāśĒöīņØś IMC ļæÉĻ╗śņØś ņä▒ņןņØ┤ ņĀüņØĆ ņØ┤ņ£ĀļŖö Cu6Sn5 IMCņŚÉ ļ╣äĒĢ┤ Ni3Sn4 IMCņØś thermal diffusivityĻ░Ć ņĀüņ¢┤ ņä▒ņןņåŹļÅäĻ░Ć ļé«ņØĆ Ļ▓āņ£╝ļĪ£ ņé¼ļŻīļÉ£ļŗż.
3) OSP Cu DBCņŚÉņä£ 125 ┬░C, 175 ┬░C Ļ│Āņś©ņŗ£ĒÜ© ņŗ£ĒŚś Ēøä Cu3Sn IMC Ļ┤Ćņ░░ Ļ▓░Ļ│╝, ļäż ņĪ░ņä▒ņØś ņåöļŹö ļ¬©ļæÉ 100ņŗ£Ļ░ä ņØ┤Ēøä Cu3Sn IMCĻ░Ć Ļ┤Ćņ░░ļÉśņŚłļŗż. Cu3Sn IMC ļæÉĻ╗śļŖö Sn-90Pb ņåöļŹöņŚÉņä£ Ļ░Ćņן ļ¦ÄņØ┤ ņä▒ņןĒĢśņśĆļŗż. OSP Cu ņÖĆ Sn-90 PbņŚÉņä£ Cu3Sn IMCĻ░Ć Ļ░Ćņן ļ¦ÄņØ┤ ņä▒ņןĒĢ£ ņØ┤ņ£ĀļŖö ņåöļŹö ļé┤ļČĆņØś Sn ĒĢ©ļ¤ēņØ┤ ņĀüĻ│Ā, SnņØś ĒÖĢņé░ņåŹļÅäĻ░Ć ļé«ņĢä Cu6Sn5 IMCņØś ņä▒ņןņØ┤ ņ¢┤ļĀżņøī Cu3Sn IMCĻ░Ć ļ¦ÄņØ┤ ņä▒ņן ĒĢ£ Ļ▓āņ£╝ļĪ£ ņé¼ļŻīļÉ£ļŗż.
4) 125 ┬░C, 175 ┬░C Ļ│Āņś©ņŗ£ĒÜ© ņŗ£ĒŚś Ēøä Ni-P, OSP Cu Ēæ£ļ®┤ņ▓śļ”¼ ļÉ£ DBCņØś Cu6Sn5 IMCņØś Ēü¼ĻĖ░ Ļ┤Ćņ░░ Ļ▓░Ļ│╝, Ļ│Āņś©ņŗ£ĒÜ© ņĪ░Ļ▒┤ņŚÉ ļö░ļźĖ Ļ▓░ņĀĢļ”ĮņØś Ēü¼ĻĖ░ļŖö Sn-5Sb ņåöļŹöĻ░Ć Ļ░Ćņן ņ╗Ėņ£╝ļ®░, SbņØś ĒĢ©ļ¤ēņØ┤ ņ”ØĻ░ĆĒĢĀņłśļĪØ Ļ▓░ņĀĢļ”Į Ēü¼ĻĖ░ļŖö ņ×æĻ▓ī ļéśĒāĆļé¼ļŗż.
References
1. J.W. Yoon, J.H. Bang, Y.H. Ko, S.H. Yoo, J.K. Kim, and C.W. Lee, Power Module Packaging Technology with Extended Reliability for Electric Vehicle Applications, J. Microelectron. Packag. Soc. 21(4) (2014) 1ŌĆō13. (in Korean)
[CROSSREF] [PDF]
[CROSSREF] [PDF]
2. J.H. Bang, D.Y. Yu, Y.H. Ko, J.W. Yoon, and C.W. Lee, Lead-free Solder for Automotive Electronics and Reliability Evaluation of Solder Joint, J. of Welding and Joining. 34(1) (2016) 26ŌĆō34. (in Korean)
[CROSSREF] [PDF]
[CROSSREF] [PDF]
3. W.S. Hong and C.M. Oh, Degradation Behavior of Solder Joint and Implementation Technology for Lead-free Automotive Electronics, Journal of KWJS. 31(3) (2013) 22ŌĆō30. (in Korean)
[CROSSREF] [PDF]
[CROSSREF] [PDF]
4. T. Hayashi, H. Tanaka, Y. Shimoida, S. Tanimoto, and M. Hoshi. New High-voltage Unipolar Mode p+Si/n-4H-SiC Heterojunction Diode. In: Proceedings of the 5th European Conference on Silicon Carbide and Related Materials, Italy; (May., 483 (485) 2005), p. 953ŌĆō956
5. R. Fu, E. Santi, and Y. Zhang, Power SiC MOSFET Model with Simplified Description of Linear and Saturation Operating Regions, International Conference on Power Electronics (ICPE). (2015) 190ŌĆō195.
[CROSSREF]
[CROSSREF]
6. J. Biela, M. Schweizer, S. Waffler, and W. Kolar. Johann, SiC versus Si-Evaluation of Potentials for Performance Improvement of Inverter and DC-DC Converter Systems by SiC Power Semiconductors, IEEE Transactions on Industrial Electronics. 58(7) (2011) 2872ŌĆō2882.
[CROSSREF]
[CROSSREF]
7. W. M. Choi and H. G. Ahn, The Switching Characteristic and Efficiency of New Generation SiC MOSFET, Journal of the Korea Institute of Information and Communication Engineering. 21(2) (2017) 353ŌĆō360.
[CROSSREF] [PDF]
[CROSSREF] [PDF]
8. X. Chen, M. Li, X. Ren, and D. Mao. Effects of alloying elements on the characteristics of Sn-Zn lead-free solder. In: 6th International Conference on Electronics Packaging Technology; (2005)
9. K.L. Lin, P.C. Liu, and J.M. Song. Wetting interaction between Pb-free Sn-Zn series solders and Cu. In: Ag substrates, Electronic Compound and Technology Conference; (2003)
10. J. Wang, L. Wen, J. Zhou, and M. Chung. Mechanical properties and joint reliability improvement of Sn-Bi alloy. In: 13th Electronics Packaging Technology Conference; (2011)
11. J. McCabe. Rodney and E. Fine. Morris, Creep of Tin, Sb-Solution-Strengthened Tin, and SbSn Precipitate-Strengthened Tin, Metallurgical and Materials Transac-tions. 33A 2002ŌĆō1531.
12. D.G. Kin and S.B. Jung, Microstructure and Mechanical Properties of Sn-0.7Cu Flip Chip Solder Bumps Using Stencil Printing Method, Materials Transactions. 46(11) (2005) 2366ŌĆō2371.
13. C.B. Lee, S.B. Jung, Y.E. Shin, and C.C. Shur, Effect of Isothermal Aging on Ball Shear Strength in BGA Joints with Sn-3.5Ag-0.75Cu Solder, Materials Transactions. 43(8) (2002) 1858ŌĆō1863.
[CROSSREF]
[CROSSREF]
14. R.J. Fields, S.R. Low, and G.K. Lucey, Physical and Mechanical Properties Of Intermetallic Compounds Commonly Found In Solder Joints, Published in Metal Science of Joining, Proceedings of TMS Symposium, Cincinnati. (1991) 20ŌĆō24.
15. M.G. Cho, Y.S. Park, S.K. Seo, K.W. Paik, and H.M. Lee, Effect of Ag on ripening growth of Cu6Sn5grains formed between molten Sn-xAg-0.5Cu solders and Cu, EPTC Proceeding. (2010) 170
16. A Hokazono. Morozumi, H. Nishimura, Y. Ikeda, Y. Nabetani, and Y. Takahashi, Direct Liquid Cooling Module with High Reliability Solder Joining Technology for Automotive Applications, 25th International Symposium on Power Semiconductor Devices & ICs. (2013) 109ŌĆō112.
[CROSSREF]
[CROSSREF]
-
METRICS

-
- 9 Crossref
- 8,687 View
- 188 Download
- Related articles
-
Laser Welding Characteristic of Dissimilar Metal for Aluminum to Steel2017 September;35(5)
Welding Characteristics of A-TIG Using Various Compositions of Active Fluxes2014 October;32(5)



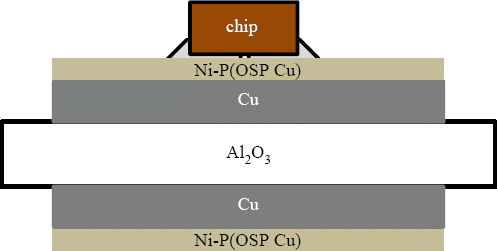
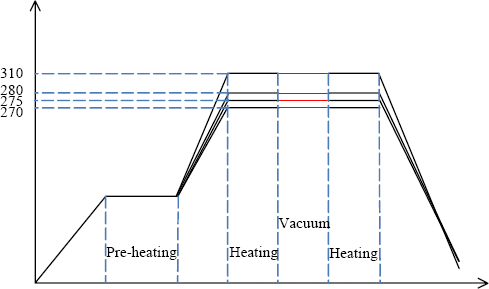
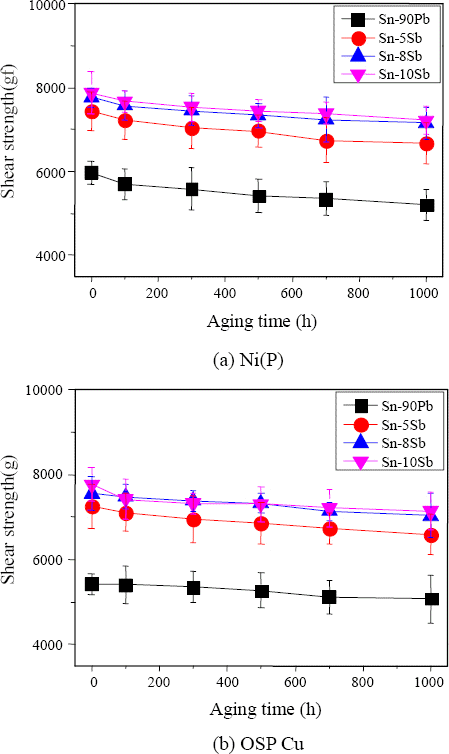
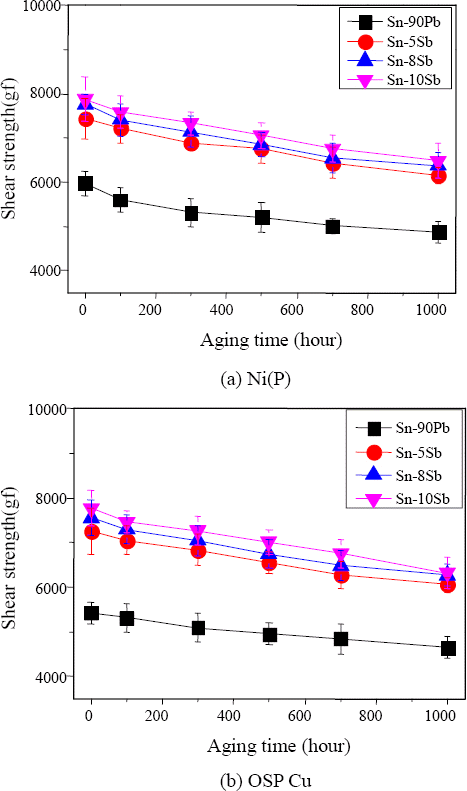




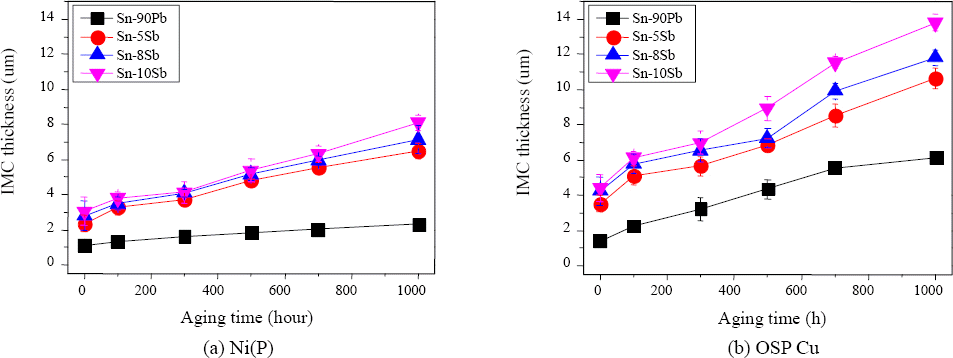



 PDF Links
PDF Links PubReader
PubReader ePub Link
ePub Link Full text via DOI
Full text via DOI Download Citation
Download Citation Print
Print


