1. European Union Council. Directive 2011/65/EU of the European Parliament and of the Council, Restriction of the use of Certain Hazardous Substances in Electrical and Electronic Equipment (RoHS). (2011)
2. European Union Council. Directive 2000/53/EC of the European Parliament and of the Council of 18 September 2000 on end-of life vehicle (ELV). (2016)
3. Haustein. Sonja and Jensen. Anders Fjendbo, Factors of electric vehicle adoption, A comparison of conventional and electric car users based on a extended theory of planned behavior,
International Journal of Sustainable Transportation. (2018) 1ŌĆō13.
https://doi.org/10.1080/15568318.2017.1398790
[CROSSREF] 4. J.G. Strandjord. Andrew, Popelar. Scott, and Jauernig. Christine, Interconnecting to aluminum-and copper-based semiconductors (electroless-nickel/gold for solder bumping and wire bonding),
Microelectronics Reliability. 42(2) (2002) 265ŌĆō283.
https://doi.org/10.1016/S0026-2714(01)00236-0
[CROSSREF] 5. Yong-Ho. Ko, Sehoon. Yoo, and Chang-Woo. Lee, Evaluation on Reliability of High Temperature Leadfree Solder for Automotive Electronics,
Journal of Microelec-tronics & Packaging Society. 17(4) (2010) 35ŌĆō40.
https://doi.org/10.5781/JWJ.2016.34.1.26
[CROSSREF] 6. Hung. Tuan-Yu, Liao. Li-Ling, C.C. Wang, W.H. Chi, and Chiang. Kuo-Ning, Life Prediction of High-Cycle Fatigue in Aluminum Bonding Wires Under Power Cycling Test,
IEEE Transactions on Device and Materials Reliability. 14(1) (2014) 484ŌĆō492.
https://doi.org/10.1109/TDMR.2013.2288703
[CROSSREF] 8. Jun-Hwan. Bang, Dong-Yurl. Yu, Young-Ho. Ko, Jeong-Won. Yoon, and Chang-Woo. Lee, Lead-free Solder for Automo-tive Electronics and Reliability Evaluation of Solder Joint,
Journal of Welding and Joining. 34(1) (2016) 26ŌĆō34.
https://doi.org/10.5781/JWJ.2016.34.1.26
[CROSSREF] [PDF] 10. Y. Yamada, Y. Takaku, Y. Yagi, I. Nakagawa, T. Atsumi, M. Shirai, I. Ohnuma, and K. Ishida, Reliaibility of wire-bonding and solder joint for high temperature operation of power semiconductor device,
Microelectronics Reliability. 47(12) (2007) 2147ŌĆō2151.
https://doi.org/10.1016/j.microrel.2007.07.102
[CROSSREF] 11. Pedersen. Kristian Bonderup, Kristensen. Peter Kjaer, Popok. Vladimir, and Pedersen. Kjeld, Micro-sectioning approach for quality and reliability assessment of wire bonding interfaces in IGBT modules,
Microelec-tronics Reliability. 53(9-11) (2013) 1422ŌĆō1426.
https://doi.org/10.1016/j.microrel.2013.07.010
[CROSSREF] 13. S. Murali, N. Srikanth, and J. Vath. Charles III, Effect of wire size on the formation of intermetallics and Kirkendall voids on thermal aging of thermosonic wire bonds,
Material Letters. 58 (2004) 3096ŌĆō3101.
https://doi.org/10.1016/j.matlet.2004.05.070
[CROSSREF] 14. Qin. Ivy, Xu. Hui, Clauberg. Horst, Cathcart. Ray, Acoff. Viola L., Chylak. Bob, and Huynh. Cuong, Wire Bonding of Cu and Pd Coated Cu Wire, Bondability, Reliabiity, and IMC Formaiton,
IEEE Electronic Components and Technology Conference. 61(2011) 1489ŌĆō1495.
https://doi.org/10.1109/ECTC.2011.5898707
[CROSSREF] 15. D.S. Liu, Y.C. Chao, and C.H. Wang, Study of wire bonding looping formaiton in the electronic packaging process using the three-dimensional finite element method,
Finite Element in Analysis and Design. 40 (2004) 263ŌĆō286.
https://doi.org/10.1016/S0168-874X(02)00226-3
[CROSSREF] 16. T. Rooney. Daniel, Nager. DeePak, Geiger. David, and Shanguan. Dongkai, Evaluation of wire bonding performance, process conditions, and metallurgical integrity of chip on board wire bonds,
Microelectronics Reliability. 45(2) (2005) 379ŌĆō390.
https://doi.org/10.1016/j.microrel.2004.06.008
[CROSSREF]

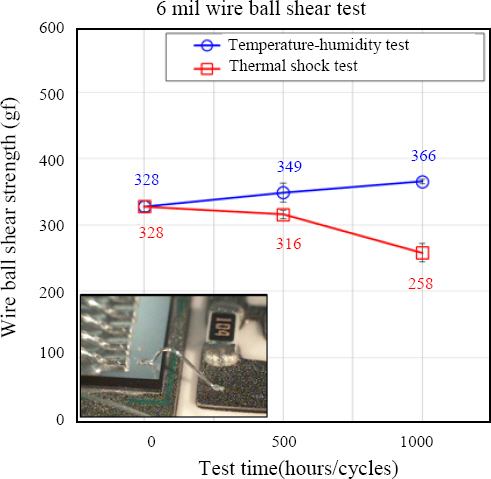

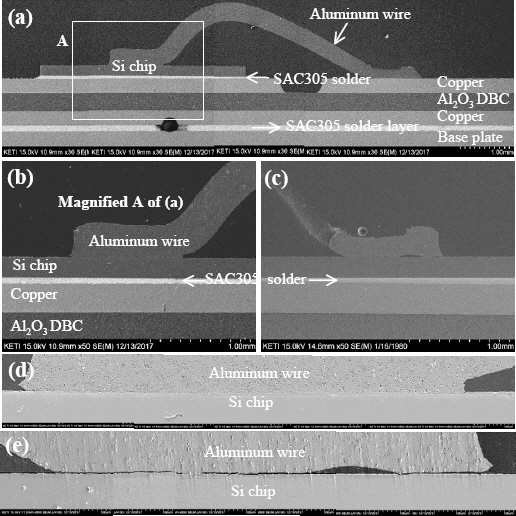
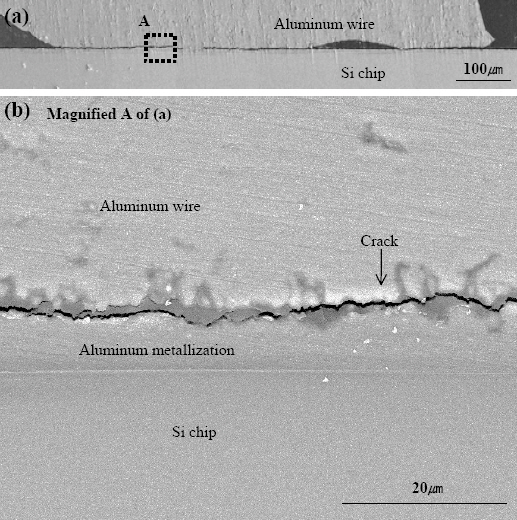
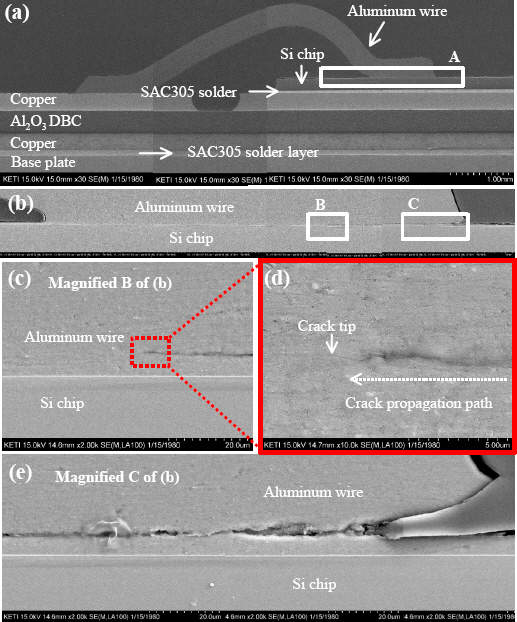





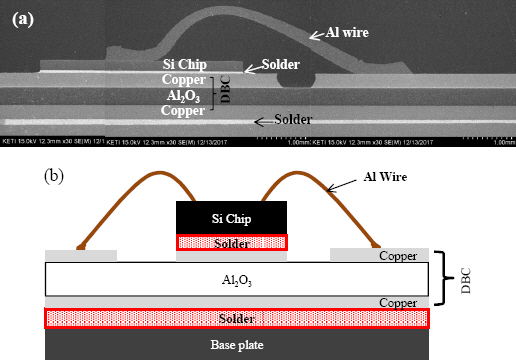
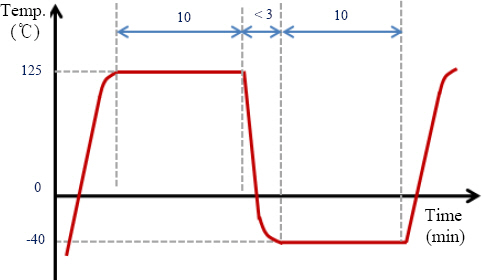
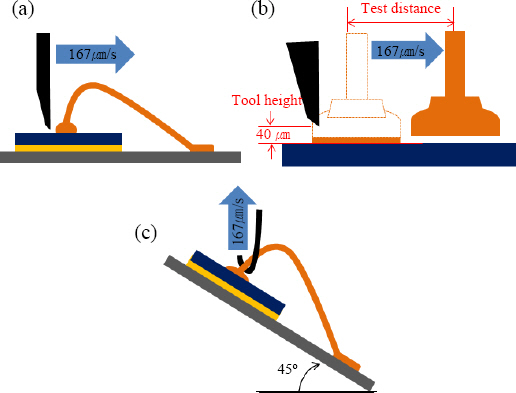
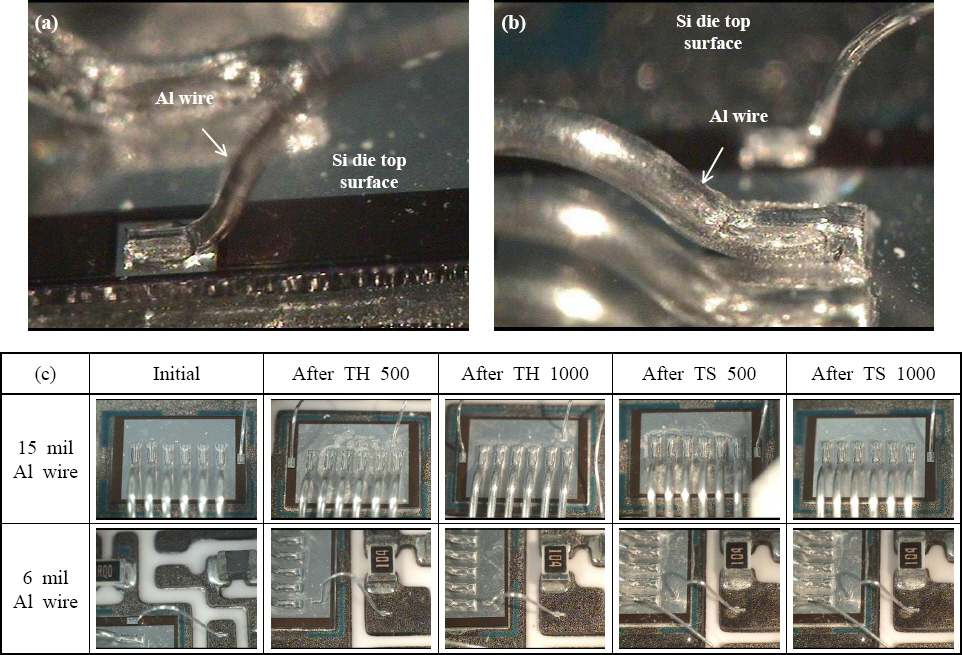

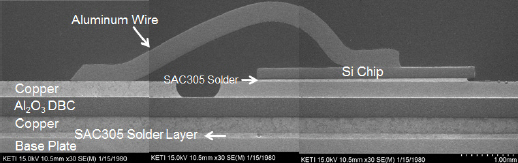

 PDF Links
PDF Links PubReader
PubReader ePub Link
ePub Link Full text via DOI
Full text via DOI Download Citation
Download Citation Print
Print



