Search
- Page Path
-
- HOME
- Search
- Bonding Property of Flip-Chip Chip-Scale Package with Vacuum Reflow and Thermal Compression Bonding Processes
- So-Hee Hyun, Hye Min Lee, Mi-Song Kim, Won Sik Hong
- J Weld Join. 2023;41(5):387-395. Published online October 31, 2023
-
 Full text
Full text  PubReader
PubReader  ePub
ePub  PDF
PDF

- Effects of Solder Powder Particle Size and Substrate Surface Finish on Degradation Properties of Solder Joints
- Mi-Song Kim, Won Sik Hong, Hye-Min Lee, Myeongin Kim
- J Weld Join. 2022;40(3):207-214. Published online June 20, 2022
-
 Full text
Full text  PubReader
PubReader  ePub
ePub  PDF
PDF

- Optimization of FC-CSP and MLCC Soldering Process Using Type 7 Solder Paste
- Hye-Min Lee, Mi-Song Kim, Myeongin Kim, Won Sik Hong
- J Weld Join. 2022;40(2):165-174. Published online April 21, 2022
-
 Full text
Full text  PubReader
PubReader  ePub
ePub  PDF
PDF
- Flip Chip - Chip Scale Package Bonding Technology with Type 7 Solder Paste Printing
- Mi-Song Kim, Won Sik Hong, Myeongin Kim
- J Weld Join. 2021;39(4):359-367. Published online August 23, 2021
-
 Full text
Full text  PubReader
PubReader  ePub
ePub  PDF
PDF
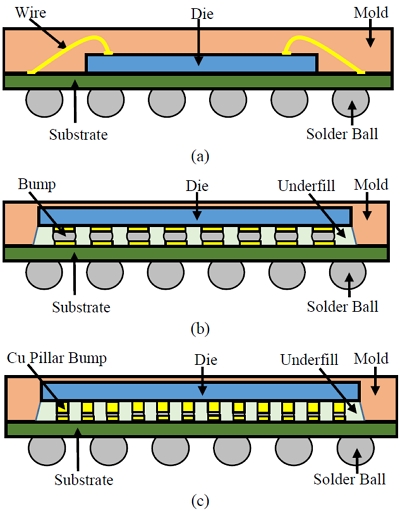
- MLCC Solder Joint Property with Vacuum and Hot Air Reflow Soldering Processes
- Won Sik Hong, Mi-Song KIm, Myeongin Kim
- J Weld Join. 2021;39(4):349-358. Published online August 11, 2021
-
 Full text
Full text  PubReader
PubReader  ePub
ePub  PDF
PDF
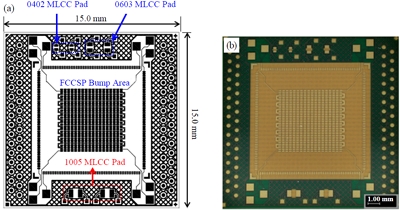
- A Study on Joint Properties of Sn-Cu-(X)Al-(Y)Si/Cu Solder by Multiple Reflow
- Dong-Yurl Yu, Jun-Hyuk Son, Yong-Ho Ko, Chang-Woo Lee, Dongjin Byun, Junghwan Bang
- J Weld Join. 2020;38(2):131-137. Published online April 28, 2020
-
 Full text
Full text  PubReader
PubReader  ePub
ePub  PDF
PDF

- Intermetallic Compounds and Mechanical Property of Sn-Cu-xCr/Cu Solder Joint by Multiple reflows Conditions
- Dong-Yurl Yu, Junhyuk Son, Yong-Ho Ko, Chang-Woo Lee, Junghwan Bang
- J Weld Join. 2018;36(2):21-27. Published online April 30, 2018
-
 Full text
Full text  PubReader
PubReader  ePub
ePub  PDF
PDF
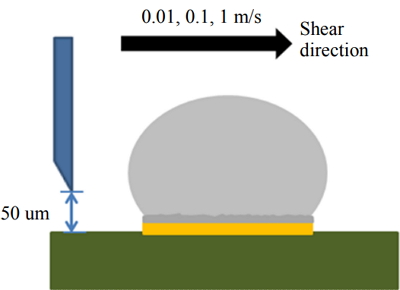
- Interfacial reactions and mechanical strength of Sn-3.0Ag-0.5Cu/0.1㎛-Ni thin ENEPIG solder joint
- Jong-Hoon Back, Sehoon Yoo, Deok-Gon Han, Seung-Boo Jung, Jeong-Won Yoon
- J Weld Join. 2017;35(6):51-58. Published online December 4, 2017
-
 Full text
Full text  PubReader
PubReader  ePub
ePub  PDF
PDF

-
Journal of
Welding and
JoiningPrint ISSN: 2466-2232
Online ISSN: 2466-2100
-
 Register for e-submission
Register for e-submission
Register here to access the e-submission system of Journal of Welding and Joining for authors and reviewers.
-
 Manuscript Submission
Manuscript Submission
To submit a manuscript, please visit the Journal of Welding and Joining e-submission management system at https://submit.e-jwj.org, read the Instructions for Authors, and log into the Journal of Welding and Joining e-submission system.
For assistance with manuscript submission, please contact: koweld@kwjs.or.kr.
-
 Free archive
Free archive
Anyone may access any past or current articles without logging in.

















