1. ņä£ ļĪĀ
ņśżļŖśļéĀ ņ╣£ĒÖśĻ▓Į ņåīņ×¼ņé¼ņÜ®ņŚÉ ļīĆĒĢ£ ĒÖśĻ▓ĮĻĘ£ņĀ£ ļ▓ĢņĢł(RoHS ļō▒)ņØĆ ņé░ņŚģņĀüņÜ® ļ▓öņ£äĻ░Ć ļ│┤ļŗż ļäōņ¢┤ņ¦ĆĻ│Ā ņ׳ļŗż. ĒŖ╣Ē׳ ņØ╝ļ░ś Ļ░ĆņĀäņØä ļ╣äļĪ»ĒĢśņŚ¼ ļģĖĒŖĖļČü, Ē£┤ļīĆņĀäĒÖö ļō▒ņØś ņĀäņ×Éļ¬©ļōłņØś ņĀ£ņĪ░ņŚÉ ņĀüņÜ®ļÉśļŖö ļ¼┤ņŚ░ņåöļŹö(Pb-free solder)ļŖö Sn-AgĻ│äļź╝ ņżæņŗ¼ņ£╝ļĪ£ Sn-CuĻ│ä, Sn-BiĻ│ä ļō▒ņŚÉ ņĀ£3ņØś ņøÉņåī Ēś╣ņØĆ ņĀ£4ņØś ņøÉņåīļź╝ ļ»Ėļ¤ē ņ▓©Ļ░ĆĒĢśļŖö ņŚ░ĻĄ¼ļōżņØ┤ ļ¦ÄņØ┤ ņŗ£ļÅäļÉśņŚłļŗż. ņØ┤ļ¤¼ĒĢ£ ņŚ░ĻĄ¼Ļ▓░Ļ│╝ļź╝ ļ░öĒāĢņ£╝ļĪ£ ņ¦Ćļé£ 10ņŚ¼ ļģäĻ░ä ļ¦ÄņØĆ ņĀäņ×ÉņĀ£ĒÆłņØ┤ ļ¼┤ņŚ░ĒÖöļÉśņŚłĻ│Ā ņä▒Ļ│ĄņĀüņ£╝ļĪ£ ņłśĒ¢ēļÉśņ¢┤ ņÖöļŗż1-2). ĻĘĖļ¤¼ļéś ĒÖśĻ▓ĮĻĘ£ņĀ£ņØś ņøĆņ¦üņ×äņØ┤ ļ│┤ļŗż ļ¦ÄņØĆ ņé░ņŚģļōżļĪ£ ņ¦äĒ¢ēļÉ©ņŚÉ ļö░ļØ╝ ļ¼┤ņŚ░ ņåöļŹöļź╝ ņĀüņÜ®ĒĢśļŖö ļ¦ÄņØĆ ņĀäņ×Éļ¬©ļōłļōżņØ┤ ļ│┤ļŗż ļåÆņØĆ ļ¼╝ņä▒Ļ│╝ ņŗĀļó░ņä▒ņØä ņÜöĻĄ¼ļ░øĻ▓ī ļÉśņŚłļŗż3). ņ¦Ćļé£ 10ņŚ¼ ļģä ļÅÖņĢł ĒÖśĻ▓ĮĻĘ£ņĀ£ ļīĆņāüņŚÉņä£ ņĀ£ņÖĖļÉśņ¢┤ ņÖöļŹś ņ×ÉļÅÖņ░© ņé░ņŚģņŚÉ ļīĆĒĢ£ ĒÖśĻ▓Į ĻĘ£ņĀ£ļÅä ņ£Āļ¤ĮņŚ░ĒĢ®(EU)ņŚÉņä£ ļ░£ņØśĒĢ£ ĒÅÉņ░© ņ▓śļ”¼ ņ¦Ćņ╣©(End-of-Life Vehicle, ELV)ņØä ņŗ£ņ×æņ£╝ļĪ£ ļ│ĖĻ▓®ĒÖöļÉĀ ņĀäļ¦ØņØ┤ļŗż. ļŹöņÜ▒ņØ┤ ņĄ£ĻĘ╝ ņ×ÉļÅÖņ░© ņé░ņŚģņØĆ Ļ░üņóģ ĒÄĖņØś/ņĢłņĀä ĻĖ░ļŖźĻ│╝ Ļ│ĀĒÜ©ņ£©ņØä ņČöĻĄ¼ĒĢśļ®┤ņä£ ņ░©ļ¤ēņÜ® ļ░śļÅäņ▓┤ ļ░Å ņĀäņןĒÆłņØś ņĀüņÜ®ņØ┤ ņ”ØĻ░ĆĒĢśĻ│Ā ņ׳ņ¢┤ 2020ļģäņŚÉļŖö ņ░©ļ¤ē ļīĆļŗ╣Ļ░ĆĻ▓®ņØś 70% ņØ┤ņāüņØ┤ ņĀäņןĒÆłņ£╝ļĪ£ ļīĆņ▓┤ļÉĀ ņĀäļ¦ØņØ┤ļŗż. ĻĘĖļ¤¼ļéś ņØ╝ļ░ś ņĀäņ×ÉņĀ£ĒÆłņŚÉ ļ╣äĻĄÉĒĢśņŚ¼ ļ│┤ļŗż Ļ░ĆĒś╣ĒĢ£ ņé¼ņÜ® ĒÖśĻ▓ĮņØä ņÜöĻĄ¼ļ░øļŖö ņ×ÉļÅÖņ░© ņĀäņןĒÆłņØś ņŗĀļó░ņä▒ņØä ļ│┤ņ”ØĒĢśĻĖ░ ņ£äĒĢ┤ņä£ļŖö Ļ│Ā ņŗĀļó░ņä▒ ņĀæĒĢ®ņåīņ×¼ņØś Ļ░£ļ░£ņØ┤ ņäĀĒ¢ēļÉśņ¢┤ņĢ╝ ĒĢ£ļŗż. Table 1ņØĆ ņ×ÉļÅÖņ░© ņĀäņןĒÆłņØś ņé¼ņÜ® ĒÖśĻ▓ĮņØä ļéśĒāĆļé┤Ļ│Ā ņ׳ļŗż. ņ×ÉļÅÖņ░© ņĀäņןĒÆłņØĆ ļŗżļźĖ ņØ╝ļ░śņĀüņØĖ ņĀ£ĒÆłĻ│╝ ļŗ¼ļ”¼ Ļ│Āņś© Ļ│ĀņŖĄ, ņŚ┤ņČ®Ļ▓®, ņ¦äļÅÖ, ņśżņŚ╝ ļō▒ņØś ļ│ĄĒĢ®ņĀüņØ┤Ļ│Ā Ļ░ĆĒś╣ĒĢ£ ņé¼ņÜ® ĒÖśĻ▓ĮņŚÉ ļģĖņČ£ļÉ£ļŗż4-5). ĒŖ╣Ē׳ ĒŖĖļ×£ņŖżļ»ĖņģśĻ│╝ ņŚöņ¦ä ņŻ╝ļ│ĆņØś ņé¼ņÜ® ņżæ ņś©ļÅäļŖö 130┬░CŌł╝150┬░CņŚÉ ņØ┤ļźĖļŗż. ļīĆĒæ£ņĀü ļ¼┤ņŚ░ ņåöļŹö ņĪ░ņä▒ņ£╝ļĪ£ ņŗĀļó░ņä▒ņØ┤ Ļ▓Ćņ”ØļÉśņ¢┤ ļäÉļ”¼ ņé¼ņÜ® ņżæņØĖ Sn-3.0Ag-0.5Cu (SAC305)ņØś Ļ▓ĮņÜ░ 217┬░CņØś ņ£ĄņĀÉņØä Ļ░¢ļŖö ņżæņś©Ļ│ä ņåöļŹöņŚÉ Ļ░ĆĻ╣īņÜ░ļ®░ ĒŖ╣ņĀĢ ĒÖśĻ▓ĮņĪ░Ļ▒┤ņŚÉņä£ ņŗĀļó░ņä▒ņØ┤ ĻĖēĻ▓®Ē׳ ņĀĆĒĢśļÉśļŖö ļ¼ĖņĀ£ļź╝ ļéśĒāĆļāäņ£╝ļĪ£ ņŚöņ¦äļŻĖ ļé┤ ņĀäņןĒÆłņŚÉ ņĀüņÜ®ĒĢśĻĖ░ņŚÉļŖö ņ¢┤ļĀżņøĆņØ┤ ņ׳ļŗż6). ļśÉĒĢ£ ņØ╝ļ░ś ĻĖ░Ļ│äņĀü ĒŖ╣ņä▒ņŗ£ĒŚś (ņĀäļŗ©Ļ░ĢļÅäņŗ£ĒŚś, Lead pull test ļō▒) Ļ│╝ ņØ╝ļ░ś ņŗĀļó░ņä▒ ņŗ£ĒŚś (ņŚ┤ ņČ®Ļ▓®ņŗ£ĒŚś, ĒĢŁņś©ĒĢŁņŖĄņŗ£ĒŚś ļō▒)ņ£╝ļĪ£ļŖö ņ×ÉļÅÖņ░©ņØś ņé¼ņÜ® ĒÖśĻ▓Į ņżæņŚÉ ņØ╝ņ¢┤ļéśļŖö ņ¦äļÅÖ, ņČ®Ļ▓® ļō▒ņØś ņÖĖļČĆņĀü ņØĖņ×Éļź╝ ļ░śņśüĒĢĀ ņłś ņŚåņ¢┤ņä£ ņŗżņĀ£ ĒīīĻ┤┤ļ¬©ļō£ņŚÉ ņØ┤ļź┤ļŖö ĒÖśĻ▓ĮņØä Ļ░ĆņåŹņĀüņ£╝ļĪ£ ņĀ£Ļ│ĄĒĢĀ ņłś ņŚåļŗż7-8). ņØ╝ļ░śņĀüņ£╝ļĪ£ ņ×ÉļÅÖņ░© ņĀäņןļ¬©ļōłņŚÉ ņĀüņÜ®ĒĢśļŖö Sn-Pb Ļ│ĄņĀĢņåöļŹöņØś ņŗĀļó░ņä▒ņØĆ ņ¦äļÅÖņŚÉ ļīĆĒĢ£ ĒÅēĻ░ĆĻ░Ć ņØ╝ļČĆ ņØ┤ļŻ©ņ¢┤ņĀĖ ņ׳ņ£╝ļéś ļ¼┤ņŚ░ņåöļŹöņØś ņåīņ×¼ ĒŖ╣ņä▒ņØä ļ░śņśüĒĢ£ Ļ▓āņØĆ ņĢäļŗśņ£╝ļĪ£ ļ│ĄĒĢ®ņ¦äļÅÖņŗ£ĒŚś ļō▒ņØä ĒżĒĢ©ĒĢśļŖö ņĀĢļ░ĆĒÅēĻ░ĆĻ░Ć ĒĢäņÜöĒĢśļŗż9-10).
Table┬Ā1
Environment of automotive electronics
ņØ┤ņŚÉ ļö░ļØ╝ ļ│Ė ņŚ░ĻĄ¼ņŚÉņä£ļŖö Sn-Cu-Cr-Ca ļ¼┤ņŚ░ņåöļŹöņØś ņĀ¢ņØīņä▒, ĻĖ░Ļ│äņĀü Ļ░ĢļÅä ļō▒ņØś ņĀæĒĢ®ļ¼╝ņä▒ņØä ĒÅēĻ░ĆĒĢśņŚ¼ ņŚöņ¦äļŻĖņÜ® ņĀäņןĒÆłņØś ņĀæĒĢ®ņåīņ×¼ļĪ£ņä£ņØś ņĀüĒĢ®ņŚ¼ļČĆļź╝ ĒÅēĻ░ĆĒĢśņśĆļŗż. ļśÉĒĢ£ ņé░ņŚģņĀüņ£╝ļĪ£ Ļ░Ćņן ļ¦ÄņØ┤ ņé¼ņÜ®ļÉśĻ│Ā ņ׳ļŖö Sn-3.5AgņØś ņåöļŹöņÖĆ ļ╣äĻĄÉņĀü ņżæĻ│Āņś©Ļ│äļĪ£ ļČäļźśĒĢĀ ņłś ņ׳ļŖö Sn-0.7Cu, Sn-5.0Sb ņåöļŹöļź╝ ņé¼ņÜ®ĒĢśņŚ¼ ļ│ĄĒĢ® ĒÖśĻ▓Įņŗ£ĒŚśņŚÉ ļö░ļźĖ ņŗĀļó░ņä▒ ĒÅēĻ░Ćļź╝ ņŚ░ĻĄ¼ĒĢ£ Ļ▓░Ļ│╝ļź╝ ĻĖ░ņłĀĒĢśņśĆļŗż.
2. Sn-Cu-Cr-Ca ņåöļŹö
2.1 ņåöļŹö ļ¬©ĒĢ®ĻĖł ņĀ£ņĪ░ ļ░Å ņŗ£ĒÄĖ ņĀ£ņ×æ
Cr, CaļŖö ņé░ĒÖöņŚÉ ņĘ©ņĢĮĒĢ©ņ£╝ļĪ£ Sn ĒśĖņØ╝(Foil)Ļ│╝ ĒĢ©Ļ╗ś ņĢĢņŚ░ĒĢśņŚ¼ ņÜ®ņ£Ąņŗ£Ēé┤ņ£╝ļĪ£ņä£ ĒĢ®ĻĖłĒÖöļź╝ ņÜ®ņØ┤ĒĢśĻ▓ī ĒĢśņśĆļŗż. ņ£ĀļÅäĻ░ĆņŚ┤ņØä ņØ┤ņÜ®ĒĢ┤ ņ¦äĻ│ĄļČäņ£äĻĖ░ņŚÉņä£ 600┬░CĻ╣īņ¦Ć ņāüņŖ╣ņŗ£Ēé© Ēøä Ar ļČäņ£äĻĖ░ņŚÉņä£ 1100┬░CļĪ£ Ļ░ĆņŚ┤ĒĢśņŚ¼ CrņØä ņÖäņĀäĒ׳ ņÜ®ĒĢ┤ņŗ£ņ╝░ļŗż. ņØ┤Ēøä ĻĘĀņ¦łĒÖö ņ▓śļ”¼ļź╝ ĒĢśĻ│Ā ICP ļČäĻ┤æĻĖ░ (In-ductively Coupled Plasma Spectrometer)ļź╝ ĒåĄĒĢśņŚ¼ ņä▒ļČäļČäņäØņØä ņ¦äĒ¢ēĒĢśņśĆņ£╝ļ®░, ņØ┤ļź╝ ĒåĄĒĢ┤ ļ»Ėļ¤ēņØś CrĻ│╝ CaņØś ņĀĢļ¤ēļČäņäØņØä Ē¢ēĒĢśņśĆĻ│Ā, Sn-0.7 wt.% Cu-0.2 wt.% Cr, Sn-0.7 wt.% Cu-0.2 wt.% Cr-0.15 wt.% CaņØś ņåöļŹöĒĢ®ĻĖł ņĪ░ņä▒ņØä ĒÖĢņØĖĒĢśņśĆļŗż. ņåöļŹö ĒÄśņØ┤ņŖżĒŖĖļŖö ņ¦äĻ│Ą Ļ░ĆņŖż ņĢäĒåĀļ¦łņØ┤ņĀĆ(Atomizer)ļź╝ ņØ┤ņÜ®ĒĢśņŚ¼ 20Ōł╝38 ┬Ąm Ēü¼ĻĖ░ņØś ĒīīņÜ░ļŹöļź╝ ņĀ£ļ”ĮĒĢ£ Ēøä RMA ĒāĆņ×ģ Ēöīļ¤¼ņŖżņÖĆ Ēś╝ĒĢ®ĒĢśņŚ¼ ņĀ£ņĪ░ĒĢśņśĆļŗż. ņĀ£ņ×æļÉ£ ņåöļŹö ĒÄśņØ┤ņŖżĒŖĖņŚÉ ļīĆĒĢ£ ņĀæĒĢ®Ļ░ĢļÅä, ņØĖņćäņä▒ņØä ĒÅēĻ░ĆĒĢśĻĖ░ ņ£äĒĢśņŚ¼ FR4 ņ×¼ņ¦łņØś ņŗ£ĒŚśĒÅēĻ░ĆņÜ® Ļ▓Įņä▒ PCBļź╝ ņĀ£ņ×æĒĢśņśĆļŗż. PCBļŖö 1005 ņé¼ņØ┤ņ”ł ļĀłņ¦ĆņŖżĒä░ ņ╣®ņØś ņĀäļŗ©Ļ░ĢļÅä, 0.08Ōł╝0.8 mm Ēī©ļō£Ļ░ä Ļ▒░ļ”¼ļź╝ Ļ░Ćņ¦ĆļŖö ņŚ░ņåŹ ņØĖņćäņä▒ ņŗ£ĒŚśņØä ĒÅēĻ░ĆĒĢśĻĖ░ ņ£äĒĢ┤ ņäżĻ│ä, ņĀ£ņ×æļÉśņŚłļŗż. ņ╣®ņØś ņĀæĒĢ®Ļ░ĢļÅä ņŗ£ĒŚśņÜ® ļ¬©ļōłņØĆ ņåöļŹö ĒÄśņØ┤ņŖżĒŖĖļź╝ ņé¼ņÜ®ĒĢśņŚ¼ ļ”¼ĒöīļĪ£ņÜ░ Ļ│Ąļ▓Ģņ£╝ļĪ£ ņĀ£ņ×æĒĢśņśĆņ£╝ļ®░ ļ”¼ĒöīļĪ£ņÜ░ Ļ│ĄņĀĢņØś ņĄ£Ļ│Ā ņś©ļÅä(Peak temperature)ļŖö 260┬░CļĪ£ ņäżņĀĢĒĢśņśĆļŗż.
2.2 ņ£ĄņĀÉ ļ░Å ņĀ¢ņØīņä▒ ņĖĪņĀĢ Ļ▓░Ļ│╝
DSC(Differential Scanning Calorimetry)ļź╝ ņØ┤ņÜ®ĒĢśņŚ¼ ņ£ĄņĀÉņØä ņĖĪņĀĢĒĢ£ Ļ▓░Ļ│╝ļź╝ Fig. 1ņŚÉ ļéśĒāĆļé┤ņŚłļŗż. Sn-Cu-CrņØĆ 230.9┬░C Sn-Cu-Cr-CaļŖö 231.3┬░CņØś ņ£ĄņĀÉņØä Ļ░üĻ░ü ļéśĒāĆļé┤ņŚłļŗż. ņŗ£ļŻīļŖö ĒĢ®ĻĖłņØś ņżæņĢÖ ļČĆļČäņŚÉņä£ 10 mg ņö® ņ▒äņĘ©ĒĢśņśĆņ£╝ļ®░, 50┬░CņŚÉņä£ ņĢłņĀĢĒÖö ņŗ£Ēé© Ēøä 10┬░C/minņ£╝ļĪ£ 300┬░CĻ╣īņ¦Ć ņāüņŖ╣ņŗ£ĒéżĻ│Ā Ļ░ÖņØĆ ņåŹļÅäļĪ£ ļāēĻ░üņŗ£ņ╝░ļŗż. Sn-0.7CuĒĢ®ĻĖłņØś Ļ│ĄņĀĢņś©ļÅäĻ░Ć 227┬░CņØĖ Ļ▓āņØä Ļ░ÉņĢłĒĢśļ®┤ CrĻ│╝ CaņØś ņ▓©Ļ░ĆļĪ£ ņĢĮ 4┬░CņØ┤ņāüņØś ņś©ļÅäņāüņŖ╣ņØ┤ ļéśĒāĆļé£ Ļ▓āņ£╝ļĪ£ ņé¼ļŻīļÉ£ļŗż. Ēśäņ×¼ ņāüņÜ®ĒÖö ļÉśņ¢┤ ņĀüņÜ®ļÉśĻ│Ā ņ׳ļŖö Ļ│Āņś©Ļ│ä ņåöļŹöļĪ£ Sn-5Sb ĒĢ®ĻĖłņØś Ļ│ĄņĀĢņś©ļÅäĻ░Ć 245┬░CņØ┤Ļ│Ā ĻĖ░ņĪ┤ņØś Ļ│Āņś©Ļ│ä ņåöļŹöņŚÉ ļīĆĒĢ┤ ļ│┤Ļ│Āļź╝ Ļ░ÉņĢłĒĢśļ®┤11) 230┬░CņØ┤ņāüņØś ņ£ĄņĀÉņØä ņ¦ĆļŗłļŖö Ļ░£ļ░£ĒĢ®ĻĖłņØĆ ņāłļĪ£ņÜ┤ ņżæĻ│Āņś©Ļ│ä ĒĢ®ĻĖłņØ┤ļØ╝Ļ│Ā ĒĢĀ ņłś ņ׳Ļ▓Āļŗż. ĒŖ╣Ē׳ SbĒĢ©ņ£Ā ņåöļŹöĻ░Ć SbņØś ņ£ĀĒĢ┤ņä▒ Ļ▓Ćņ”Øņ£╝ļĪ£ ņ¦ĆņåŹņĀü ņé¼ņÜ®ņØ┤ ļČłĒł¼ļ¬ģĒĢ£ Ļ▓āņØä Ļ│ĀļĀżĒĢśļ®┤ ņżæņś©Ļ│ä ņåöļŹö ņĀüņÜ®ņŚÉ ļīĆĒĢ£ ļīĆņĢłņ£╝ļĪ£ņä£ ņĀüņÜ®ļÉĀ ņłś ņ׳ņØä Ļ▓āņ£╝ļĪ£ ĒīÉļŗ©ļÉ£ļŗż. Fig. 2ļŖö Wetting balance ņŗ£ĒŚśĻĖ░ļź╝ ņØ┤ņÜ®ĒĢśņŚ¼ ņÜ®ņ£ĄņåöļŹöņŚÉ ļīĆĒĢ£ Cu ņ┐ĀĒÅ░ņØś ņĀ¢ņØīļĀźņØä ņĖĪņĀĢĒĢ£ Ļ▓░Ļ│╝ņØ┤ļŗż. SAC305ņÖĆ Sn-Cu-CrņØĆ ņĢĮ 2 mNņ£╝ļĪ£ ļÅÖļō▒ĒĢ£ ņłśņżĆņØś ņĀ¢ņØīļĀźņØä ļéśĒāĆļé┤ņŚłņ¦Ćļ¦ī, Sn-Cu-Cr-CaņØĆ SAC305 ņåöļŹöņŚÉ ļ╣äĻĄÉĒĢśņŚ¼ ĒÅēĻĘĀ 5% Ļ░Ćļ¤ē ļé«ņØĆ ņĀ¢ņØīļĀźņØä ļéśĒāĆļé┤ņŚłļŗż. ņØ┤ļŖö CaņØś ņé░ĒÖöļÅäĻ░Ć ļŗżļźĖ ņøÉņåīņŚÉ ļ╣äĻĄÉĒĢśņŚ¼ ļåÆĻĖ░ ļĢīļ¼ĖņŚÉ CaņØś ņé░ĒÖöĻ░Ć Cu padņÖĆņØś Ēæ£ļ®┤ ļ░śņØæņØä ļ░®ĒĢ┤ĒĢśņŚ¼ ņĀ¢ņØīļĀźņØä ņĀĆĒĢśņŗ£Ēé© Ļ▓āņ£╝ļĪ£ ņČöņĖĪļÉ£ļŗż. CaņØś ņ╣£ņé░ĒÖöļĀźņØĆ ļ¼╝ņä▒ņĀ£ņ¢┤Ļ░Ć ņ¢┤ļĀĄĻĖ░ ļĢīļ¼ĖņŚÉ ņåöļŹö ĒÄśņØ┤ņŖżĒŖĖ ņĀ£ņĪ░ņŗ£ņŚÉ ņé░ĒÖöļ¦ē ņĀ£Ļ▒░ņØś ĒÜ©Ļ│╝ļź╝ ņ”Øņ¦äņŗ£ĒéżĻĖ░ ņ£äĒĢ£ Ēöīļ¤ŁņŖż Ļ░£ļ░£Ļ│╝ ĒĢ©Ļ╗ś reflow Ļ│ĄņĀĢņŚÉņä£ ņśłļ╣ä Ļ░ĆņŚ┤ņś©ļÅäņÖĆ Ļ│ĄņĀĢņŗ£Ļ░äņØś ņĄ£ņĀüĒÖöļź╝ ņØ┤ļŻ©ļŖö Ļ│ĄņĀĢ ņĪ░Ļ▒┤ņØä Ļ░£ļ░£ĒĢśļŖö Ļ▓āņØ┤ ņ¢æņé░Ļ│ĄņĀĢņŚÉņä£ ĒĢäņÜöĒĢśļ”¼ļØ╝ ņé¼ļŻīļÉ£ļŗż.
2.3 ĒŹ╝ņ¦Éņä▒ ļ░Å ņĀæĒĢ®Ļ░ĢļÅä Ļ▓░Ļ│╝
ņÜ®ņ£Ąņŗ£Ēé© ņåöļŹöņÖĆ Cu pad Ēæ£ļ®┤Ļ│╝ņØś ņĀæņ┤ēĻ░üņØä ņĀæņ┤ēĻ░ü ņŗ£ĒŚśĻĖ░ļź╝ ņØ┤ņÜ®ĒĢśņŚ¼ ņĖĪņĀĢĒĢ£ Ēøä ņåöļŹöņØś ĒŹ╝ņ¦Éņ£©ņØä ņĢäļלņØś ņĀĢņØśļź╝ ņØ┤ņÜ®ĒĢśņŚ¼ ņé░ņČ£ĒĢśņśĆļŗż.
Sn-Cu-Cr ņåöļŹöņØś Cu padņŚÉ ļīĆĒĢ£ ĒŹ╝ņ¦Éņ£©ņØĆ ņĢĮ 84┬▒2%ņØś Ļ▓░Ļ│╝ļź╝ ļéśĒāĆļé┤ņŚłļŗż. ņāüļīĆņĀü ļ╣äĻĄÉļź╝ ņ£äĒĢśņŚ¼ SAC305ņÖĆ Sn-0.7CuņåöļŹöņØś ĒŹ╝ņ¦Éņä▒ņØä ņĖĪņĀĢĒĢ£ Ļ▓░Ļ│╝, SAC305 ņāüņÜ® ņåöļŹöņØś Ļ▓ĮņÜ░ ņĢĮ 85%, Sn-0.7Cu ņāüņÜ® ņåöļŹöļŖö 82%ņØś ĒŹ╝ņ¦Éņ£©ņØä ļéśĒāĆļé┤ņŚłļŗż. ĒŹ╝ņ¦Éņä▒ņØĆ ņåīņ×¼ņØś Ļ│äļ®┤ņןļĀźĻ│╝ Ļ┤ĆļĀ©ļÉśļŖö ļ¼╝ņä▒ņ×äņØä Ļ│ĀļĀżĒĢśļ®┤ ĻĖ░ņĪ┤ ņāüņÜ®ņåöļŹöņØś Ļ│äļ®┤ņןļĀźĻ│╝ ņ£Āņé¼ĒĢ£ Ļ░ÆņØä ņ¦ĆļŗīļŗżĻ│Ā ĒīÉļŗ©ļÉ£ļŗż. ņØ┤ļŖö ņāüņś©ņŚÉņä£ ņŗ£ĒŚśĒĢśņśĆņØä ļĢī Ēöīļ¤¼ņŖżņØś ņśüĒ¢źņØä ļ¦ÄņØ┤ ļ░øĻ▓ī ļÉśĻĖ░ ļĢīļ¼ĖņŚÉ ņåöļŹö ņ×Éņ▓┤ņØś ļ¼╝ņä▒ņ£╝ļĪ£ ĒÅēĻ░ĆĒĢśĻĖ░ļŖö ņ¢┤ļĀżņÜ░ļéś, Ēöīļ¤¼ņŖżņØś ņśüĒ¢źņØä ļÅÖņØ╝ĒĢśļŗżĻ│Ā Ļ░ĆņĀĢĒĢśņśĆņØä ļĢī ņāüņÜ®ņåöļŹöņŚÉ ļ¼╝ņä▒ņØä ļ¦īņĪ▒ĒĢśļŖö Ļ▓āņ£╝ļĪ£ ņé¼ļŻīļÉ£ļŗż.
1005 ņ╣®ņØś ņĀäļŗ©Ļ░ĢļÅä Ļ▓░Ļ│╝ļź╝ Fig. 3ņŚÉ ļéśĒāĆļé┤ņŚłļŗż. SAC305 ņåöļŹöņÖĆ ļ╣äĻĄÉĒĢśņŚ¼ CrĻ│╝ Cr-CaņØ┤ ĒĢ©ņ£ĀļÉ£ ļæÉ ņĪ░ņä▒ņØ┤ ļŗżņåī ļé«Ļ▓ī ļéśĒāĆļé¼ņ¦Ćļ¦ī, ņśżņ░©ļ▓öņ£ä ņØ┤ļé┤ņŚÉņä£ Ēü░ ņ░©ņØ┤ļź╝ ļ│┤ņØ┤ņ¦Ć ņĢŖņĢśņ£╝ļ®░, ļŗ©ņ£äļ®┤ņĀüļŗ╣ ņĀæĒĢ®Ļ░ĢļÅäļŖö 1.25 kg/mm2 ņ£╝ļĪ£ ņ¢æĒśĖĒĢ£ Ļ░ÆņØä ļéśĒāĆļé┤ņŚłļŗż. ņØ┤ļŖö reflowĻ│ĄņĀĢņŚÉņä£ ņśłņŚ┤ņŗ£Ļ░äĻ│╝ ņś©ļÅäļČäņ£äĻĖ░ļź╝ ņČ®ļČäĒ׳ ņāüņŖ╣ņŗ£ņ╝£ Ēöīļ¤ŁņŖżņØś ĒÖ£ņä▒ĒÖöļź╝ ņ£ĀļÅäĒĢśņŚ¼ ņåöļŹö ĒÄśņØ┤ņŖżĒŖĖ ļé┤ ņé░ĒÖöļ¦ēņØä ņĀ£Ļ▒░ĒĢśĻ│Ā voidņÖĆ Ļ░ÖņØĆ Ļ▓░ĒĢ©ņØ┤ ņŚåņØ┤ ņĀæĒĢ®ļČĆļź╝ ĒśĢņä▒ĒĢ£ Ļ▓░Ļ│╝ļĪ£ ĒīÉļŗ©ļÉ£ļŗż. Fig. 4ņØś ļŗ©ļ®┤ ņĀäņ×ÉĒśäļ»ĖĻ▓Į ņé¼ņ¦äņŚÉņä£ ņåöļŹöņØś ļé┤ļČĆņÖĆ Ļ│äļ®┤ņŚÉņä£ Ļ▓░ĒĢ©ņØ┤ ņŚåļŖö ņ¢æĒśĖĒĢ£ ņĀæĒĢ®ļČĆņØś ĒśĢņāüņØä ļ│┤ņŚ¼ņŻ╝Ļ│Ā ņ׳ļŗż.
2.4 ĻĖłņåŹĻ░äĒÖöĒĢ®ļ¼╝ ļČäņäØ
Fig. 4ņØĆ ņĀæĒĢ® ĒøäņØś ņåöļŹö ļé┤ļČĆņŚÉ ļ»ĖņäĖņĪ░ņ¦üĻ│╝ ĒĢ©Ļ╗ś Sn-Cu-Cr ņĪ░ņä▒ņØś ņåöļŹöļ¦ü Ēøä ņĀæĒĢ®Ļ│äļ®┤ņŚÉ ĒśĢņä▒ļÉśļŖö ĻĖłņåŹĻ░ä ĒÖöĒĢ®ļ¼╝ņØä ļ│┤ņŚ¼ņŻ╝Ļ│Ā ņ׳ļŗż. Cu6Sn5 ĻĖłņåŹĻ░äĒÖöĒĢ®ļ¼╝ņĖĄņØ┤ 2~4 ┬ĄmļæÉĻ╗śņØś ļČłĻĘĀņØ╝ ĒśĢĒā£ļĪ£ ĒśĢņä▒ļÉśņ¢┤ ņ׳ņ£╝ļ®░, ņåöļŹö ļé┤ļČĆ ņāü(phase)ņØĖ ╬▓-Sn ļé┤ņŚÉļÅä ĻĖłņåŹĻ░ä ĒÖöĒĢ®ļ¼╝ ņ×ģņ×É(IMC particle)Ļ░Ć ņØ╝ļČĆ ļČäĒżĒĢśĻ│Ā ņ׳ņŚłļŗż. ņØ┤ļŖö Sn-CuņåöļŹöņŚÉņä£ ļéśĒāĆļéśļŖö ņĪ░ņ¦üĻ│╝ ļ╣äĻĄÉĒĢśņŚ¼ ņ£Āņé¼ĒĢ£ ļ»ĖņäĖņĪ░ņ¦üņØä ļéśĒāĆļé┤ļ®░, EDS ļČäņäØĻ▓░Ļ│╝ CrņØ┤ Ļ│äļ®┤ņŚÉņä£ļŖö ļ░£Ļ▓¼ļÉśņ¦Ć ņĢŖņØĆ Ļ▓āņ£╝ļĪ£ ļéśĒāĆļéśņä£ ╬▓-Snļé┤ņŚÉ ļČäņé░ļÉśņ¢┤ ņ׳ņØä Ļ▓āņ£╝ļĪ£ ņé¼ļŻīļÉ£ļŗż.
ņØ┤ļŖö ICP ņĀĢļ¤ēņĀü ļČäņäØĻ▓░Ļ│╝, CrņØś ĒĢ©ņ£Āļ¤ēņØ┤ ĒÖĢņØĖļÉśņŚłņØīņØä Ļ│ĀļĀżĒĢśļ®┤ CrņØś ņ▓©Ļ░Ćļ¤ēņØ┤ ļ¦żņÜ░ ņĀüņ¢┤ņä£ EDSņØś ļČäĒĢ┤ļŖźņ£╝ļĪ£ ĒÖĢņØĖņØ┤ ņ¢┤ļĀżņÜ┤ Ļ▓āņ£╝ļĪ£ ĒīÉļŗ©ļÉśļ®░ Ļ│äļ®┤ņŚÉņä£ņØś ĒÄĖņäØĒśäņāüņØĆ ņŚåņŚłņØīņØä ĒÖĢņØĖĒĢ£ Ļ▓░Ļ│╝ņØ┤ļŗż. Fig. 5ļŖö 150┬░CņŚÉņä£ Ļ░ü 100ņŗ£Ļ░äĻ│╝ 300ņŗ£Ļ░ä aging ņŗ£ĒŚś Ēøä ĻĖłņåŹĻ░ä ĒÖöĒĢ®ļ¼╝ņĖĄņØś ļæÉĻ╗śļ│ĆĒÖöļź╝ ņĖĪņĀĢĒĢ£ Ļ▓░Ļ│╝ņØ┤ļŗż. Sn-CuļŖö ņ┤łĻĖ░ļæÉĻ╗ś 3.3 ┬ĄmņŚÉņä£ 300ņŗ£Ļ░ä Ēøä 8.4 ┬ĄmļĪ£ 5.1 ┬Ąm ņ”ØĻ░ĆĒĢ£ļŹ░ ļ╣äĒĢ┤ Sn-Cu-Cr ĒĢ®ĻĖłņØĆ ņĢĮ 1.4 ┬Ąm ņ”ØĻ░ĆĒĢśņśĆļŗż. ņ┤Ø ĻĖłņåŹĻ░ä ĒÖöĒĢ®ļ¼╝ ļæÉĻ╗śļź╝ ļ╣äĻĄÉĒĢśļ®┤ Sn-Cu-CrņŚÉņä£ ļ░£ņāØĒĢ£ Cu6Sn5 ĻĖłņåŹĻ░ä ĒÖöĒĢ®ļ¼╝ņØś ļæÉĻ╗śļŖö Sn-0.7Cu ĒĢ®ĻĖłņŚÉņä£ ļ░£ņāØĒĢ£ ĻĖłņåŹĻ░ä ĒÖöĒĢ®ļ¼╝ņØś ņĢĮ 50%ņŚÉ ĒĢ┤ļŗ╣ĒĢśļŖö ļæÉĻ╗śļĪ£ ĒśäņĀĆĒ׳ ĻĖłņåŹĻ░ä ĒÖöĒĢ®ļ¼╝ņØś ļ░£ņāØ ļ░Å ņä▒ņןņØ┤ ņĀüņØĆ Ļ▓āņØä ņĢī ņłś ņ׳ļŗż. ņØ┤ļŖö ĻĖ░ņĪ┤ņØś ņŚ░ĻĄ¼12-15)ņØĖ Sn-Ag-Bi-Cr ĒĢ®ĻĖłĻ│äņØś ņŗżĒŚśņŚÉņä£ CrņØś ņ▓©Ļ░ĆĻ░Ć Cu6Sn5ņØś ĒśĢņāüņØä ņ┤łĻĖ░ ņ╗¼ļ¤╝ļ¤¼ ĻĄ¼ņĪ░ņŚÉņä£ CrņØś ņ▓©Ļ░ĆņŚÉ ļö░ļØ╝ ļØ╝ņÜ┤ļō£ ĒāĆņ×ģņØś ĒśĢņāüņ£╝ļĪ£ ļ░öļĆīĻ▓ī ļÉśņ¢┤ SnņØś ĒÖĢņé░ņØ┤ ņ¢ĄņĀ£ļÉ©ņ£╝ļĪ£ ņØĖĒĢ┤ IMCņØś ņä▒ņןņØ┤ ņĀüņ¢┤ņ¦ĆĻ▓ī ļÉ£ļŗżļŖö ļ│┤Ļ│ĀņÖĆ ņל ņØ╝ņ╣śĒĢśĻ│Ā ņ׳ļŗż. Sn-Cu-Cr-Ca ĒĢ®ĻĖłņØś Ļ▓ĮņÜ░, Sn-Cu-CrĻ│╝ ļ¦żņÜ░ ņ£Āņé¼ĒĢ£ Ļ▓░Ļ│╝ļź╝ ļéśĒāĆļé┤ņ¢┤ Caņ▓©Ļ░ĆņŚÉ ļīĆĒĢ£ ņśüĒ¢źņØ┤ ļéśĒāĆļéśņ¦Ć ņĢŖņĢśļŗżĻ│Ā ĒīÉļŗ©ļÉ£ļŗż. Ļ▓░Ļ│╝ņĀüņ£╝ļĪ£ CrņØś ņ▓©Ļ░ĆļŖö ĻĖłņåŹĻ░äĒÖöĒĢ®ļ¼╝ņØś ņä▒ņןņØä ņ¢ĄņĀ£ĒĢśļŖö ĒÜ©Ļ│╝ļź╝ ļéśĒāĆļé┤ļŖö Ļ▓āņ£╝ļĪ£ ļéśĒāĆļé¼ļŗż. ņØ┤ņĀäņØś ņŚ░ĻĄ¼12-15)ņŚÉ ļö░ļź┤ļ®┤, CrņØś ņ▓©Ļ░ĆņŚÉ ļīĆĒĢ┤ Sn-Ag-Bi-CrĒĢ®ĻĖłņŚÉ ļīĆĒĢ┤ CrĻ│╝ CaņØś SnņŚÉ ļīĆĒĢ£ Ļ│ĀņÜ®ļÅäĻ░Ć ņŚåņØīņØä Ļ│ĀļĀżĒĢ┤ ļ│┤ļ®┤ Ļ▓░ņĀĢļ”ĮĻ│ä Ēś╣ņØĆ Ļ│äļ®┤ ĻĘ╝ņ▓śņŚÉ ņĪ┤ņ×¼ĒĢśļŖö CrņØ┤ ĻĖłņåŹĻ░ä ĒÖöĒĢ®ļ¼╝ņØś ĒśĢņä▒ ļ░Å ņØ┤ļÅÖņØä ļ░®ĒĢ┤ĒĢśņŚ¼ IMCņØś ļæÉĻ╗śņ”ØĻ░ĆĻ░Ć ņĀüņØĆ Ļ▓āņ£╝ļĪ£ ņČöņĖĪļÉśļéś, Ē¢źĒøäņØś ņŚ░ĻĄ¼ņŚÉņä£ ĻĖłņåŹĻ░ä ĒÖöĒĢ®ļ¼╝ņØś ĒśĢņä▒ņ¢ĄņĀ£ ĻĖ░ņĀäĻ│╝ ņØ┤Ļ▓āņØ┤ ņĀæĒĢ®ļČĆ ņŗĀļó░ņä▒ņŚÉ ļ»Ėņ╣śļŖö ņśüĒ¢źņŚÉ ļīĆĒĢ£ ņŚ░ĻĄ¼Ļ░Ć ĒĢäņÜöĒĢśļ”¼ļØ╝ ĒīÉļŗ©ļÉ£ļŗż.
3. Sn3.5Ag, Sn0.7Cu, Sn5.0Sb ņåöļŹö
3.1 ņŗ£ĒÄĖ ņĀ£ņ×æ ļ░Å ņŗ£ĒŚś ņĪ░Ļ▒┤
ļ│Ė ņŚ░ĻĄ¼ņŚÉ ņé¼ņÜ®ļÉ£ ņåöļŹöņØś ņĪ░ņä▒ņØĆ Sn-3.5Ag, Sn-0.7Cu, Sn-5.0SbņØ┤ņŚłņ£╝ļ®░ ņåöļŹöļ│╝ņØś ņ¦üĻ▓ĮņØĆ 450 ┬ĄmņØ┤ņŚłļŗż. ļ¬©ļōĀ ņĪ░ņä▒ņØĆ ĒŖ╣ļ│äĒĢ£ ņ¢ĖĻĖēņØ┤ ņŚåļŖö ĒĢ£ wt.%ļĪ£ Ēæ£ĻĖ░ĒĢśņśĆļŗż. BGAņØś Ļ▓ĮņÜ░ Cu Ēī©ļō£ļź╝ ENIGļĪ£ Ēæ£ļ®┤ņ▓śļ”¼ ĒĢśņśĆĻ│Ā, PCB BoardļŖö Cu Ēī©ļō£ļź╝ OSP ņ▓śļ”¼ļź╝ ņŗżņŗ£ĒĢśņśĆļŗż. PCB ņ£äņŚÉ ņåöļŹöļ│╝Ļ│╝ Ļ░ÖņØĆ ņĪ░ņä▒ņØä Ļ░Ćņ¦ĆļŖö ņåöļŹöĒÄśņØ┤ņŖżĒŖĖļź╝ ļÅäĒżĒĢ£ Ēøä, BGA ņ╣®ņØä ļ¦łņÜ┤ĒŖĖĒĢśĻ│Ā ļ”¼ĒöīļĪ£ņÜ░ļź╝ ņØ┤ņÜ®ĒĢśņŚ¼ ņ╣®Ļ│╝ ĻĖ░ĒīÉņØä ņĀæĒĢ®ĒĢśņśĆļŗż.
ņØ┤ ļĢī, ņĀæĒĢ®ņØ┤ ņÖäļŻīļÉ£ BGAņ╣®Ļ│╝ ĻĖ░ĒīÉņØĆ ļŹ░ņØ┤ņ¦Ć ņ▓┤ņØĖņ£╝ļĪ£ ņŚ░Ļ▓░ļÉśņ¢┤ ņĀäĻĖ░ņĀĆĒĢŁņØä ņĖĪņĀĢĒĢĀ ņłś ņ׳Ļ▓ī ĒĢśņśĆļŗż16). Fig. 6ņØĆ ņĀæĒĢ®ņØ┤ ņÖäļŻīļÉ£ ņāüĒā£ņØś ņĀ£ņ×æļÉ£ ņŗ£ĒÄĖ ņØ┤ļ»Ėņ¦ĆņØ┤ļŗż. ņŚ┤Ēö╝ļĪ£ ņŗ£ĒŚśņØĆ ņŚ┤ņČ®Ļ▓®ņŗ£ĒŚśĻ│╝ ņŚ┤ņŗĖņØ┤Ēü┤ņŗ£ĒŚś, ļæÉ ņóģļźśņØś ļ░®ļ▓Ģņ£╝ļĪ£ ņ¦äĒ¢ēĒĢśņśĆļŗż. ņŚ┤ņČ®Ļ▓® ņŗ£ĒŚśņØĆ VT 7012 S2 (Votsch Co.)ņןļ╣äļź╝ ņØ┤ņÜ®ĒĢśņŚ¼ ņ¦äĒ¢ēĒĢśņśĆņ£╝ļ®░, ņŚ┤ņŗĖņØ┤Ēü┤ ņŗ£ĒŚśņØĆ VCS 7027-15(Votsch Co.)ņןļ╣äļź╝ ņØ┤ņÜ®ĒĢśņśĆļŗż. ņŚ┤ņČ®Ļ▓® ņŗ£ĒŚśņØś Ļ▓ĮņÜ░ Ļ│Āņś©Ļ│╝ ņĀĆņś© ņ▒öļ▓äļĪ£ ĻĄ¼ņä▒ļÉśņ¢┤ ņ׳ņ£╝ļ®░ ņŚśļ”¼ļ▓ĀņØ┤Ēä░ ļ░®ņŗØņ£╝ļĪ£ ĻĖēņåŹĒĢśĻ▓ī 10ņ┤ł ņØ┤ļé┤ņŚÉņä£ ņŗ£ĒÄĖņØ┤ Ļ│Āņś© ņśüņŚŁĻ│╝ ņĀĆņś© ņśüņŚŁņØä ņØ┤ļÅÖĒĢśļ®░ ņŗ£ĒŚśņØ┤ ņ¦äĒ¢ēļÉśļŖö ļ░®ņŗØņØ┤ļŗż. ņŚ┤ņŗĖņØ┤Ēü┤ ņŗ£ĒŚśņØś Ļ▓ĮņÜ░ņŚÉļŖö ĒĢśļéśņØś ņ▒öļ▓äļé┤ņŚÉņä£ ņäżņĀĢļÉ£ ļāēĻ░ü, Ļ░ĆņŚ┤ ņåŹļÅäņŚÉ ļö░ļØ╝ ņĀĆņś©Ļ│╝ Ļ│Āņś© ņśüņŚŁņŚÉņä£ņØś ņŗ£ĒŚśņØś ņ¦äĒ¢ēļÉ£ļŗż. ņŚ┤ņČ®Ļ▓®, ņŚ┤ņŗĖņØ┤Ēü┤ ņŗ£ĒŚśņØś ņś©ļÅä ļ▓öņ£äļŖö ņ×ÉļÅÖņ░©ņØś ņé¼ņÜ® ĒÖśĻ▓ĮņØĖ -40~150┬░C ņØ┤ņŚłņ£╝ļ®░ Ļ│Āņś©Ļ│╝ ņĀĆņś©ņŚÉņä£ņØś ņ£Āņ¦Ć ņŗ£Ļ░äņØĆ Ļ░ü 10ļČäņØ┤ņŚłĻ│Ā ĒĢ£ ņŗĖņØ┤Ēü┤ņØś ņŗ£Ļ░äņØĆ 25ļČä ņØ┤ņŚłļŗż. ņŗ£ĒŚśņØĆ Ļ░üĻ░ü 1500 ņŗĖņØ┤Ēü┤Ļ╣īņ¦Ć ņ¦äĒ¢ēĒĢśņśĆļŗż. ļ│ĄĒĢ®ņ¦äļÅÖņŗ£ĒŚśņØś Ļ▓ĮņÜ░ ņ¦äļÅÖņØä Ļ░ĆĒĢśļ®┤ņä£ ņś©ļÅä ņĪ░Ļ▒┤ņØä ļ│ĆĒÖöņ╝░ļŖöļŹ░, ņØ┤ ļĢī ņś©ļÅä ņĪ░Ļ▒┤ņØĆ 8ņŗ£Ļ░ä ļÅÖņĢł -40~150┬░CņØś ņś©ļÅä ļ│ĆĒÖöļź╝ ņżĆ Ēøä, 12ņŗ£Ļ░ä ļÅÖņĢł ņāüņś©ņØś ņś©ļÅä ņĪ░Ļ▒┤ņØä ņ£Āņ¦ĆĒĢśņśĆļŗż. ļ│ĄĒĢ®ņ¦äļÅÖņŗ£ĒŚśņØś ņ¦äļÅÖņĪ░Ļ▒┤ņØĆ ņŻ╝ĒīīņłśĻ░Ć 10~1,000 Hz, ņ¦äļÅÖĻ░ĆņåŹļÅäļŖö 27.8 m/s2ņśĆļŗż. ņ£äņÖĆ Ļ░ÖņØĆ ņ¦äļÅÖļ│ĄĒĢ®ņŗ£ĒŚśņØä x, y, zņČĢ ņ░©ļĪĆļīĆļĪ£ 1ĒÜīņö® ņŗżņŗ£ĒĢśņśĆĻ│Ā, ļŗżņŗ£ 1ĒÜīņö® ļŹö ņŗżņŗ£ĒĢśņŚ¼ ņ┤Ø 120ņŗ£Ļ░äņØś ļ│ĄĒĢ®ņ¦äļÅÖņŗżĒŚśņØä ņŗżņŗ£ĒĢśņśĆļŗż. Fig. 7ņØĆ ļ│ĄĒĢ® ĒÖśĻ▓Įņ¦äļÅÖņŗ£ĒŚśņØś ļ¬©ņŗØļÅäņØ┤ļŗż.
3.2 ņĀäĻĖ░ņĀü ņŗĀļó░ņä▒ ĒÅēĻ░Ć Ļ▓░Ļ│╝
ņŚ┤ņČ®Ļ▓®, ņŚ┤ņé¼ņØ┤Ēü┤, ļ│ĄĒĢ®ņ¦äļÅÖņŗ£ĒŚśņŚÉ ļö░ļźĖ ņĀäĻĖ░ ņĀĆĒĢŁņØś ļ│ĆĒÖöļź╝ Fig. 8ņŚÉ ļÅäņŗ£ĒĢśņśĆļŗż. ņŗ£ĒŚś ņŗ£Ļ░äņØ┤ ņ”ØĻ░ĆĒĢśļ®┤ņä£ ļ¬©ļōĀ ļ¼┤ņŚ░ ņåöļŹöņŚÉņä£ ņĀäĻĖ░ ņĀĆĒĢŁņØ┤ ņ”ØĻ░ĆĒĢśļŖö Ļ▓ĮĒ¢źņØä ļéśĒāĆļé┤ņŚłļŗż. ĻĘĖļ¤¼ļéś ņŚ┤ņČ®Ļ▓®, ņŚ┤ņŗĖņØ┤Ēü┤ ņŗ£ĒŚś Ļ▓░Ļ│╝, ņŗĖņØ┤Ēü┤ ņłśĻ░Ć ņ”ØĻ░Ć ĒĢĀņłśļĪØ Sn-0.7Cu, Sn-5.0Sb ņåöļŹöņŚÉ ļ╣äĒĢśņŚ¼ Sn-3.5Ag ņåöļŹöņØś ņĀäĻĖ░ ņĀĆĒĢŁ ņ”ØĻ░Ćņ£©ņØ┤ ĻĖēĻ▓®ĒĢśĻ▓ī ņ”ØĻ░ĆĒĢśļŖö Ļ▓āņØä ĒÖĢņØĖ ĒĢĀ ņłś ņ׳ņŚłļŗż. Ļ░ü ņŗ£ĒŚśņØ┤ 1500 ņŗĖņØ┤Ēü┤ ņ¦äĒ¢ēļÉ£ Ēøä, Sn-3.5Ag ņåöļŹöņØś Ļ▓ĮņÜ░ ņ┤łĻĖ░ ņĀĆĒĢŁ ļīĆļ╣ä ņŚ┤ņŗĖņØ┤Ēü┤ ņŗ£ĒŚśņØĆ 253%, ņŚ┤ņČ®Ļ▓® ņŗ£ĒŚśņØĆ 203%ņØś ņĀĆĒĢŁ ņ”ØĻ░Ćļź╝ ļ│┤ņśĆļŗż. ļ░śļ®┤ņŚÉ Sn-0.7CuņÖĆ Sn-5.0Sb ņåöļŹöļŖö ņŚ┤ņŗĖņØ┤Ēü┤ ņŗ£ĒŚśņØś Ļ▓ĮņÜ░ņŚÉļŖö 1500 ņŗĖņØ┤Ēü┤ ņØ┤Ēøä 35%, 44%Ļ░Ć ņ”ØĻ░ĆĒĢśņśĆņ£╝ļ®░ ņŚ┤ņČ®Ļ▓®ņŗ£ĒŚśņØś Ļ▓ĮņÜ░ņŚÉļŖö 25%, 32%ņØś ņ”ØĻ░Ćļ¤ēņØä ļ│┤ņśĆļŗż. ļ│ĄĒĢ®ņ¦äļÅÖņŗ£ĒŚśņØś Ļ▓ĮņÜ░ņŚÉļŖö Sn-3.5AgņØś ņĀäĻĖ░ņĀĆĒĢŁ ņ”ØĻ░Ćļ¤ēņØĆ 120 ņŗ£Ļ░ä Ēøä 35%ņØ┤ņŚłņ£╝ļ®░ Sn-0.7CuņÖĆ Sn-5.0SbļŖö Ļ░üĻ░ü 7%, 10%ņØś ņ”ØĻ░Ćļ¤ēņØä ļ│┤ņŚ¼, ņŚ┤Ēö╝ļĪ£ ņŗ£ĒŚśņŚÉņä£ ļ╣äņŖĘĒĢśĻ▓ī Sn-3.5AgĻ░Ć ĻĖēĻ▓®ĒĢśĻ▓ī ņ”ØĻ░ĆĒĢśļŖö Ļ▓ĮĒ¢źņØä ļéśĒāĆļāłņŚłļŗż. Kang17) ļō▒ņØĆ ļ®ĆĒŗ░ ļ”¼ĒöīļĪ£ņÜ░ Ēś╣ņØĆ ņŗ£ĒÜ©ņ▓śļ”¼ņŗ£ ņĀäĻĖ░ ņĀĆĒĢŁņØ┤ ņ”ØĻ░ĆĒĢśļŖö Ļ▓āņØä Ļ┤Ćņ░░ĒĢśņśĆņ£╝ļ®░, ņØ┤ļ¤¼ĒĢ£ ņĀĆĒĢŁņ”ØĻ░ĆņØś ņØ┤ņ£ĀļŖö Ļ│äļ®┤ IMC ņ”ØĻ░ĆņÖĆ Ēü¼ļ×Ö ļō▒ ļé┤ļČĆĻ▓░ĒĢ© ņ”ØĻ░ĆņŚÉ ĻĖ░ņØĖĒĢśļŖö Ļ▓āņ£╝ļĪ£ ļ│┤ņĢśļŗż. ļ│Ė ņŚ░ĻĄ¼ņŚÉņä£ļÅä ņŗĀļó░ņä▒ ņŗ£ĒŚś ņŗ£Ļ░ä ņ”ØĻ░ĆņŚÉ ļö░ļØ╝ ņĀäĻĖ░ ņĀĆĒĢŁņØ┤ ņ”ØĻ░ĆĒĢśļŖö ņØ┤ņ£Ā ņŚŁņŗ£ Ļ│äļ®┤ IMCņØś ņä▒ņןļō▒ņŚÉ ĻĖ░ņØĖĒĢśļŖö Ļ▓āņ£╝ļĪ£ ņé¼ļŻīļÉ£ļŗż. ĒŖ╣Ē׳, Sn-3.5AgņŚÉ ļīĆĒĢ┤ņä£ļŖö ņåöļŹö Ļ│äļ®┤ņŚÉ ĒśĢņä▒ļÉśļŖö ĒīÉņāüņØś Ag3SnņØ┤ ņä▒ņןĒĢśļ®┤ņä£ ņĀäĻĖ░ņĀĆĒĢŁņØś ņ”ØĻ░ĆņŚÉ ļ│┤ļŗż ĻĖ░ņŚ¼ĒĢśļŖö Ļ▓āņ£╝ļĪ£ ļ│┤ņØĖļŗż. Fig. 8ņØś Ļ▓░Ļ│╝ņŚÉņä£ Sn-0.7CuņÖĆ Sn-5.0SbĻ░Ć Sn-3.5AgņŚÉ ļ╣äĒĢśņŚ¼ ņŚ┤ņČ®Ļ▓®, ņŚ┤ņŗĖņØ┤Ēü┤Ļ│╝ Ļ░ÖņØĆ ņŚ┤Ēö╝ļĪ£ ĒÖśĻ▓ĮņØ┤ļéś ļ│ĄĒĢ®ņ¦äļÅÖ ĒÖśĻ▓ĮņŚÉņä£ ņāüļīĆņĀüņ£╝ļĪ£ ņĢłņĀĢņĀüņ×äņØä ņĢī ņłś ņ׳ņŚłļŗż.
3.3 ĻĖ░Ļ│äņĀü ņŗĀļó░ņä▒ ĒÅēĻ░Ć Ļ▓░Ļ│╝
Ļ░ü ņŗĀļó░ņä▒ ņŗ£ĒŚś ĒøäņØś ņĀäļŗ© Ļ░ĢļÅä ņŗ£ĒŚś Ļ▓░Ļ│╝ļź╝ Fig. 9ņŚÉ ļÅäņŗ£ĒĢśņśĆļŗż. ņĀæĒĢ® ņ┤łĻĖ░ņØś Ļ░ĢļÅäļź╝ ļ│┤ļ®┤, Sn-0.5SbļŖö 29.2 kgf, Sn-3.5AgļŖö 28.1 kgf, Sn-0.7CuļŖö 23.1 kgfļĪ£ Sn-0.7CuĻ░Ć Ļ░Ćņן ļé«ņØĆ Ļ░ÆņØä ļéśĒāĆļé┤ņŚłļŗż. ĻĘĖļ¤¼ļéś Sn-3.5AgņÖĆ Sn-5.0SbņØś Ļ▓ĮņÜ░ņŚÉļŖö Ļ░ü ņŗ£ĒŚśņØś ņŗĖņØ┤Ēü┤ņØ┤ ņ”ØĻ░Ć ĒĢĀņłśļĪØ ņĀæĒĢ® Ļ░ĢļÅäĻ░Ć Ēü¼Ļ▓ī Ļ░ÉņåīĒĢśļŖö Ļ▓ĮĒ¢źņØä ļéśĒāĆļé┤ņŚłļŗż. ņŚ┤ņŗĖņØ┤Ēü┤ņØś Ļ▓ĮņÜ░ 750 ņŗĖņØ┤Ēü┤ ņ¦äĒ¢ē Ēøä Ļ░Éņåīņ£©ņØĆ Sn-3.5AgņÖĆ Sn-5.0SbĻ░Ć Ļ░üĻ░ü 35%, 28%ņØ┤ņŚłņ£╝ļ®░ 1500 ņŗĖņØ┤Ēü┤ ņ¦äĒ¢ē ĒøäņŚÉļŖö Ļ░üĻ░ü 58%, 55%ņØś Ļ░Éņåīņ£©ņØä ļéśĒāĆļé┤ņŚłļŗż. ņŚ┤ņČ®Ļ▓® ņŗ£ĒŚśņØś Ļ▓ĮņÜ░ņŚÉļÅä ņŚ┤ņŗĖņØ┤Ēü┤Ļ│╝ ņ£Āņé¼ĒĢśĻ▓ī Sn-3.5AgņÖĆ Sn-5.0SbņØś Ļ░Éņåīņ£©ņØĆ 750 ņŗĖņØ┤Ēü┤ ĒøäņŚÉļŖö Ļ░üĻ░ü 45%, 21%ņØ┤ņŚłņ£╝ļ®░ 1500 ņŗĖņØ┤Ēü┤ ņ¦äĒ¢ē ĒøäņŚÉļŖö Ļ░üĻ░ü 55%, 51%ņØś Ļ░Éņåīņ£©ņØä ļéśĒāĆļé┤ņŚłļŗż. ļ░śļ®┤ņŚÉ Sn-0.7CuņØś Ļ▓ĮņÜ░ņŚÉļŖö ņ┤łĻĖ░ Ļ░ĢļÅäĻ░Ć ļé«ņØīņŚÉļÅä ņŚ┤ņČ®Ļ▓®, ņŚ┤ņŗĖņØ┤Ēü┤ ņŗ£ĒŚś Ļ▓░Ļ│╝ ļŗżļźĖ ļæÉ ņåöļŹöņŚÉ ļ╣äĒĢśņŚ¼ Ļ░ĢļÅäņØś Ļ░Éņåīņ£©ņØ┤ ļé«ņĢśļŗż. ņŚ┤ņŗĖņØ┤Ēü┤ ņŗ£ĒŚśĻ│╝ ņŚ┤ņČ®Ļ▓® 750 ņŗĖņØ┤Ēü┤ ņ¦äĒ¢ē Ļ▓░Ļ│╝ Ļ░ĢļÅäņØś Ļ░ÉņåīļŖö Ļ░üĻ░ü 10%, 3%ņØ┤ņŚłņ£╝ļ®░, 1500 ņŗĖņØ┤Ēü┤ ņ¦äĒ¢ē ĒøäņŚÉļŖö Ļ░üĻ░ü 40%, 30%ņØś Ļ░Éņåīņ£©ņØä ļéśĒāĆļé┤ņŚłļŗż. ĒŖ╣Ē׳ 750 ņŗĖņØ┤Ēü┤Ļ╣īņ¦ĆņØś Ļ░ĢļÅä Ļ░ÉņåīļŖö ņŚ┤Ēö╝ļĪ£ ņŗ£ĒŚśņŚÉņä£ ļŗżļźĖ ļæÉ ņåöļŹöņŚÉ ļ╣äĒĢ┤ Ēø©ņö¼ ļé«ņĢśļŗż. Fig. 8ņØś ņĀäĻĖ░ ņĀĆĒĢŁņØś ļ│ĆĒÖöņÖĆ ļ╣äĻĄÉĒĢĀ ļĢī, Sn-3.5AgņØś Ļ▓ĮņÜ░ ņŚ┤Ēö╝ļĪ£ ņŗ£ĒŚśņØ┤ ņ¦äĒ¢ēļÉ©ņŚÉ ļö░ļØ╝ ņĀäĻĖ░ ņĀĆĒĢŁņØ┤ ĻĖēĻ▓®ĒĢśĻ▓ī ņ”ØĻ░ĆĒĢśĻ│Ā, ņĀæĒĢ® Ļ░ĢļÅäļŖö ļ░śļīĆļĪ£ ļæÉļō£ļ¤¼ņ¦ĆĻ▓ī Ļ░ÉņåīĒĢśļŖö Ļ┤ĆĻ│äļź╝ ļéśĒāĆļāłņŚłļŗż. ļ│ĄĒĢ®ņ¦äļÅÖņŗ£ĒŚśņØś Ļ▓ĮņÜ░ņŚÉļÅä ņŚ┤ņČ®Ļ▓®, ņŚ┤ņŗĖņØ┤Ēü┤ ņŗ£ĒŚśĻ│╝ Ļ░ÖņØĆ ņŚ┤Ēö╝ļĪ£ ņŗ£ĒŚś Ļ▓░Ļ│╝ņÖĆ ņ£Āņé¼ĒĢśĻ▓ī ņŗ£ĒŚś ņŗ£Ļ░äņØ┤ ņ”ØĻ░ĆĒĢĀņłśļĪØ ņĀæĒĢ® Ļ░ĢļÅäĻ░Ć ņ┤łĻĖ░ Ļ░ÆņŚÉ ļ╣äĒĢ┤ Ļ░ÉņåīĒĢśļŖö Ļ▓ĮĒ¢źņØä ļéśĒāĆļé┤ņŚłļŗż. Sn-3.5AgņØś Ļ▓ĮņÜ░ņŚÉļŖö 120ņŗ£Ļ░ä ņŗ£ĒŚś ņ¦äĒ¢ē Ēøä ņ┤łĻĖ░Ļ░ÆņŚÉ ļ╣äĒĢśņŚ¼ 27%ļéś Ļ░ÉņåīĒĢśņśĆĻ│Ā, Sn-5.0SbņØś Ļ▓ĮņÜ░ņŚÉļŖö 60ņŗ£Ļ░äĻ╣īņ¦ĆļŖö 14% Ļ░Ćļ¤ē Ļ░ÉņåīĒĢśļŗżĻ░Ć 120ņŗ£Ļ░ä ĒøäņŚÉļŖö 15%ļĪ£ Ļ░ÉņåīĒĢśņŚ¼ ņ┤łĻĖ░ņØś Ļ░Éņåī ĒÅŁņŚÉ ļ╣äĒĢ┤ Ļ░Éņåīļ¤ēņØ┤ ņżäņ¢┤ļō£ļŖö Ļ▓ĮĒ¢źņØä ļéśĒāĆļé┤ņŚłļŗż. ļ░śļ®┤ņŚÉ Sn-0.7CuņØś 120ņŗ£Ļ░ä ĒøäņØś Ļ░Éņåīņ£©ņØĆ 7% ņłśņżĆņ£╝ļĪ£ ņŚ┤Ēö╝ļĪ£ ņŗ£ĒŚśņŚÉņä£ņÖĆ ņ£Āņé¼ĒĢśĻ▓ī ņĀæĒĢ®Ļ░ĢļÅäņØś Ļ░ÉņåīĻ░Ć ņ×æņĢä, ņāüļīĆņĀüņ£╝ļĪ£ ņóŗņØĆ ņŗĀļó░ņä▒ņØä ļ│┤ņśĆļŗż. Fig. 9ņØś Ļ▓░Ļ│╝ņŚÉņä£ ņŚ┤Ēö╝ļĪ£ ļ░Å ļ│ĄĒĢ®ņ¦äļÅÖ ĒÖśĻ▓ĮņŚÉņä£ Sn-3.5AgņÖĆ Sn-5.0SbņŚÉ ļ╣äĒĢśņŚ¼ Sn-0.7CuĻ░Ć ļ│┤ļŗż ņĢłņĀĢņĀüņØ┤ļØ╝ ĒĢĀ ņłś ņ׳ļŗż.
3.4 ļŗ©ļ®┤ ļ░Å Ēīīļ®┤ ļČäņäØ
PCBņØś CuņĖĄĻ│╝ ņåöļŹöĻ░äņØś ņĀæĒĢ® ļŗ©ļ®┤ņØä Ļ┤Ćņ░░ĒĢśņŚ¼ ņĀæĒĢ® ņ┤łĻĖ░ ņāüĒā£ņÖĆ ņŚ┤ņŗĖņØ┤Ēü┤ ņŗ£ĒŚś ĒøäņØś ļŗ©ļ®┤ņØä Fig. 10ņŚÉ ļéśĒāĆļé┤ņŚłļŗż. Ļ░ü ņåöļŹöņØś Ļ│äļ®┤ ļ░śņØæņ£╝ļĪ£ ņāØĻĖ┤ IMCņØś ņĪ░ņä▒ņØĆ Sn-3.5Ag, Sn-0.7Cu, Sn-5.0Sb ļ¬©ļæÉ ļÅÖņØ╝ĒĢśĻ▓ī Cu6Sn5ņØ┤ņŚłļŗż. Sn-3.5AgņØś Ļ▓ĮņÜ░ņŚÉ ņŚ┤ņŗĖņØ┤Ēü┤ ņŗ£ĒŚś 1500 ņŗĖņØ┤Ēü┤ Ēøä IMCļŖö 4.24 ┬ĄmņŚÉņä£ 4.78 ┬ĄmņĀĢļÅäļĪ£ ņä▒ņןĒĢśņśĆĻ│Ā ņĪ░ļīĆĒÖöļÉ£ IMCļōżņØś ņŖżĒÅ┤ļ¦ü ĒśäņāüņØ┤ ļéśĒāĆļé¼ļŖöļŹ░ ņĀæĒĢ® Ļ░ĢļÅäņØś ņĀĆĒĢśņŚÉ ļ¦ÄņØĆ ņśüĒ¢źņØä ļ»Ėņ╣£ Ļ▓āņ£╝ļĪ£ ņé¼ļŻīļÉ£ļŗż. Sn-5.0SbņØś Ļ▓ĮņÜ░ IMCļŖö ņ┤łĻĖ░ņŚÉ 4.24 ┬ĄmņŚÉņä£ ņŗ£ĒŚś Ēøä 5.87 ┬ĄmĻ╣īņ¦Ć ņä▒ņןĒĢśņśĆļŗż. Sn-0.7CuņØś Ļ▓ĮņÜ░ņŚÉļŖö IMCņØś ļæÉĻ╗śĻ░Ć 1.96 ┬ĄmņŚÉņä£ 2.64 ┬ĄmļĪ£ ņä▒ņןĒĢśņśĆņ£╝ļ®░, Sn-3.5AgņÖĆ Sn-5.0SbņŚÉ ļ╣äĒĢśņŚ¼ IMCņØś ļæÉĻ╗śĻ░Ć ņĀæĒĢ® ņ┤łĻĖ░ ļ░Å ņŗ£ĒŚś ĒøäņŚÉļÅä Ļ░Ćņן ņ¢ćņØĆ Ļ▓āņØä ĒÖĢņØĖĒĢśņśĆļŗż. ņØ┤ļŖö ņåöļŹö ļé┤ņŚÉ ĒĢ©ņ£ĀļÉśņ¢┤ ņ׳ļŖö CuĻ░Ć ņØ┤ļ»Ė Ļ│ĄņĀĢņĪ░ņä▒Ļ╣īņ¦Ć ĒĢ©ņ£ĀļÉśņ¢┤ ņ׳ņ¢┤ PCBņØś Cu ĒÖĢņé░ ĻĄ¼ļÅÖļĀźņØä Ļ░Éņåī ņŗ£ņ╝░ĻĖ░ ļĢīļ¼Ėņ£╝ļĪ£ ņČöņĖĪļÉ£ļŗż. BGA chipņ¬ĮņØś Ni(P)ņĖĄĻ│╝ ņåöļŹö Ļ░äņØś ņĀæĒĢ® ņ┤łĻĖ░ ļ░Å ņŚ┤ņŗĖņØ┤Ēü┤ ņŗ£ĒŚś ĒøäņØś ļŗ©ļ®┤ņØä Fig. 11ņŚÉ ļéśĒāĆļé┤ņŚłļŗż. ņĀæĒĢ®ļČĆņØś IMCļŖö Sn-3.5AgņÖĆ Sn-5.0SbņØś Ļ▓ĮņÜ░ņŚÉļŖö Ni3Sn4ņØ┤ņŚłļŗż. ļ░śļ®┤ņŚÉ, Sn-0.7CuņØś Ļ▓ĮņÜ░ņŚÉļŖö (Cu, Ni)6Sn5Ļ░Ć ĒśĢņä▒ļÉ©ņØä ĒÖĢņØĖĒĢśņśĆļŗż. IMCņØś ļæÉĻ╗śļŖö Sn-3.5AgĻ░Ć 5.33 ┬ĄmņŚÉņä£ 6.41 ┬ĄmļĪ£ ņä▒ņןĒĢśņśĆĻ│Ā Sn-5.0SbņØś Ļ▓ĮņÜ░ 2.87 ┬ĄmņŚÉņä£ 3.86 ┬ĄmĻ╣īņ¦Ć ņä▒ņןĒĢśņśĆļŗż. Sn-0.7CuņØś Ļ▓ĮņÜ░ņŚÉļŖö 1.55 ┬ĄmņŚÉņä£ 1.98 ┬Ąm ņä▒ņןņØä ļ│┤ņśĆļŖöļŹ░ PCBņ¬ĮņŚÉņä£ņÖĆ Ļ░ÖņØ┤ Ļ░Ćņן ņ¢ćņØĆ IMC ļæÉĻ╗śļź╝ ļéśĒāĆļé┤ņŚłļŗż. ļ│ĄĒĢ®ņ¦äļÅÖņŗ£ĒŚś Ēøä ņĀäļŗ© Ļ░ĢļÅä ņŗ£ĒŚśņŚÉ ļö░ļźĖ Ēīīļ®┤ņØä Ļ┤Ćņ░░ĒĢ£ ņé¼ņ¦äņØ┤ Fig. 12ņŚÉ ļéśĒāĆļéś ņ׳ļŗż. Sn-3.5AgņØś Ļ▓ĮņÜ░ņŚÉļŖö ņĘ©ņä▒ĒīīĻ┤┤ņØś Ļ▓ĮĒ¢źņØä ļéśĒāĆļāłņ£╝ļ®░, Sn-5.0SbņØś Ļ▓ĮņÜ░ņŚÉļŖö ņĘ©ņä▒ĒīīĻ┤┤ņÖĆ ņŚ░ņä▒ĒīīĻ┤┤Ļ░Ć ļÅÖņŗ£ņŚÉ ļéśĒāĆļéśļŖö Ļ▓ĮĒ¢źņØä ļ│┤ņśĆļŗż. ļ░śļ®┤ Sn-0.7CuņØś Ļ▓ĮņÜ░ņŚÉļŖö ņŚ░ņä▒ĒīīĻ┤┤Ļ░Ć ņÜ░ņäĖĒĢ£ Ēīīļŗ©ļ®┤ņØä ļ│┤ņśĆļŗż. ĒīīĻ┤┤ ļ¬©ļō£ņØś ņ¢æņāüņØ┤ ņ░©ņØ┤Ļ░Ć ļéśļŖö Ļ▓āņØĆ IMC ļæÉĻ╗śņŚÉ ļīĆĒĢ£ ņśüĒ¢źĻ│╝ ņåöļŹö ļé┤ļČĆņŚÉ ĒśĢņä▒ļÉśļŖö IMCsņØś ņóģļźś ļ░Å ĒśĢņāüņŚÉ ĻĖ░ņØĖĒĢśļŖö Ļ▓āņ£╝ļĪ£ ņāØĻ░üļÉ£ļŗż. Sn-0.7CuņØś Ļ▓ĮņÜ░ ņŚ┤Ēö╝ļĪ£ ņŗ£ĒŚś ļ░Å ļ│ĄĒĢ®ņ¦äļÅÖņŗ£ĒŚśņŚÉņä£ ņŗ£ĒŚś ņĀäĒøä IMCņØś ļæÉĻ╗ś ņ”ØĻ░ĆĻ░Ć ļæÉļō£ļ¤¼ņ¦ĆĻ▓ī ļéśĒāĆļéśņ¦Ć ņĢŖņĢśņ£╝ļ®░ ņäĖ Ļ░Ćņ¦ĆņØś ļ¼┤ņŚ░ ņåöļŹö ņżæņŚÉņä£ Ļ░Ćņן ņ¢ćņØĆ ļæÉĻ╗śļź╝ ļéśĒāĆļé┤ņŚłļŗż. ļśÉĒĢ£ Sn-3.5AgņØś Ļ▓ĮņÜ░ņŚÉ Fig. 13ņŚÉņä£ ļ│┤ļŖö ļ░öņÖĆ Ļ░ÖņØ┤ Ļ░ü ņŗ£ĒŚś Ēøä Ag3SnņØ┤ ņĪ░ļīĆĒÖöļÉśļŖö Ļ▓āņØä ĒÖĢņØĖ ĒĢĀ ņłś ņ׳ņŚłļŗż. Sn-3.5Ag ņåöļŹöņŚÉņä£ Ļ░ü ņŗĀļó░ņä▒ ņŗ£ĒŚś Ēøä ņĀæĒĢ® Ļ░ĢļÅäĻ░Ć Ēü¼Ļ▓ī Ļ░ÉņåīĒĢśļŖö ņØ┤ņ£ĀļŖö ņĪ░ļīĆĒÖö ļÉ£ Ag3SnņØś ņśüĒ¢źņ£╝ļĪ£ ņāØĻ░üļÉ£ļŗż. ĻĘĖļ”¼Ļ│Ā Sn-5.0SbņØś Ļ▓ĮņÜ░ Sn-3.5AgņŚÉ ļ╣äĒĢ┤ ņ×æņ¦Ćļ¦ī, ņ┤łĻĖ░ ņĀæĒĢ® Ļ░ĢļÅä ļīĆļ╣ä Ēü░ Ļ░ĢļÅä ņĀĆĒĢśļź╝ ļéśĒāĆļé┤ļŖö ņØ┤ņ£ĀļÅä ņāüļīĆņĀüņ£╝ļĪ£ ļæÉĻ║╝ņÜ┤ IMCņŚÉ ĻĖ░ņØĖĒĢ£ Ļ▓āņ£╝ļĪ£ ņāØĻ░üļÉ£ļŗż. Date18)ļō▒ņØĆ ņČ®Ļ▓® ņŗ£ĒŚśņŚÉņä£ ņŗ£ĒÜ©ņ▓śļ”¼ ļÉ£ Ļ▓ĮņÜ░ ņĀæĒĢ® Ļ░ĢļÅäņØś ņĀĆĒĢśĻ░Ć ņØ╝ņ¢┤ļéśļŖö ņøÉņØĖņ£╝ļĪ£ IMCņØś ņ”ØĻ░ĆņÖĆ Ļ▓░ĒĢ© ņāØņä▒ņŚÉ ņØśĒĢ£ Ēīīļŗ© ļ¬©ļō£ņØś ļ│ĆĒÖöĻ░Ć ņøÉņØĖņØ┤ļØ╝Ļ│Ā ĒĢśņśĆļŖöļŹ░, ļ│Ė ņŚ░ĻĄ¼ņŚÉņä£ļÅä ņĀæĒĢ® Ļ░ĢļÅäņØś ņĀĆĒĢśļŖö ņŗ£ĒŚś ņ¦äĒ¢ē ļÅÖņĢłņØś IMC ņ”ØĻ░Ćļéś Ļ▓░ĒĢ©ņØś ņāØņä▒ņ£╝ļĪ£ ņØĖĒĢśņŚ¼ ņØ╝ņ¢┤ļéśļŖö Ļ▓āņ£╝ļĪ£ ņāØĻ░üļÉśļ®░, Ēīīļŗ©ļ®┤ņØś Ļ┤Ćņ░░ņŚÉņä£ ļéśĒāĆļéśļŖö Ļ▓āĻ│╝ Ļ░ÖņØ┤ ņØ╝ļČĆ ļ▓ĮĻ│äĒīīĻ┤┤ ņ¢æņāü19)ņØä ļéśĒāĆļé┤ļŖö Ļ▓āņ£╝ļĪ£ ļ│┤ņĢä Ēü¼ļ×Ö ĒśĢņä▒ņŚÉ ļö░ļźĖ ņĘ©ņä▒ ĒīīĻ┤┤ņØś ņ¢æņāüļÅä ĒĢ©Ļ╗ś ļéśĒāĆļé┤Ļ│Ā ņ׳ļŗż.
Fig.┬Ā10
Cross section SEM images of the three lead-free solders at PCB side after thermal cycle test. (a)Sn-3.5Ag, (b)Sn-0.7 Cu, and (c)Sn-5.0Sb

Fig.┬Ā11
Cross section SEM images at BGA chip side after thermal cycle test (a)Sn-3.5Ag, (b)Sn-0.7 Cu, and (c)Sn-5.0Sb
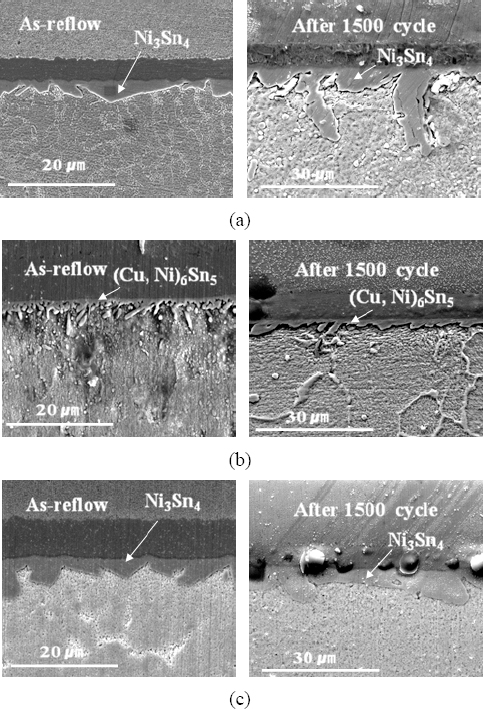
4. Ļ▓░ ļĪĀ
ņ×ÉļÅÖņ░© ņé░ņŚģņŚÉ ņĀüņÜ®ĒĢśļŖö ņĀäņ×Éļ¬©ļōłņØś ņŗĀļó░ņä▒ņŚÉ ļīĆĒĢ£ ĒÅēĻ░Ć ļ░Å Ļ│ĄņĀĢņŚÉ ļīĆĒĢ£ Ļ░£ņäĀņØĆ ļ╣äļŗ© ļ│ĄĒĢ® ņ¦äļÅÖņŗ£ĒŚśļ¦īņŚÉ ĻĄŁĒĢ£ļÉśņ¢┤ ņ׳ņ¦ĆļŖö ņĢŖļŗż. ļé┤ ņČ®Ļ▓®ņä▒, ļ»ĖņäĖĻĄ¼ņĪ░ļ│ĆĒÖöņŚÉ ļö░ļźĖ ĻĖ░Ļ│äņĀü Ļ░ĢļÅäļ│ĆĒÖö ļō▒ ļ¦ÄņØĆ ņŗĀļó░ņä▒ ņØĖņ×Éļź╝ Ļ▓Ćņ”ØĒĢ┤ņĢ╝ ļ¼┤ņŚ░ņåöļŹöņØś ņĢłņĀĢņĀü ņĀüņÜ®ņØä ĻĖ░ļīĆĒĢĀ ņłś ņ׳ņ£╝ļ”¼ļØ╝ ņāØĻ░üĒĢ£ļŗż. ĻĘĖļ¤¼ļéś ĻĖ░ņĪ┤ņØś ņØ╝ļ░ś ņĀäņ×ÉņĀ£ĒÆłņŚÉ ļ╣äĻĄÉĒĢśņŚ¼ ņś©ļÅä, ņŖĄļÅä, ņÖĖļČĆņĀü ņ¦äļÅÖ, ņČ®Ļ▓® ļō▒ ļ│┤ļŗż ļ¦ÄĻ│Ā ļ│Ąņ×ĪĒĢ£ ņÖĖļČĆ ņé¼ņÜ® ĒÖśĻ▓ĮņØ┤ Ļ│ĀļĀżļÉśņ¢┤ņĀĖņĢ╝ ĒĢśĻĖ░ ļĢīļ¼ĖņŚÉ ņĀäļźśņØĖĻ░Ćļź╝ ĒżĒĢ©ĒĢ£ ļ│ĄĒĢ® ĒÖśĻ▓ĮņØś ņĪ░Ļ▒┤ņŚÉņä£ ĻĖ░Ļ│äņĀü, ņĀäĻĖ░ņĀü ļ¼╝ņä▒ļ│ĆĒÖöļź╝ Ļ┤Ćņ░░ĒĢśņŚ¼ ņé¼ņÜ®ņ×É ņĪ░Ļ▒┤ņŚÉ ļ¦īņĪ▒ĒĢśļŖö Ļ│ĄņĀĢĻ│╝ ņåīņ×¼Ļ░Ć Ļ░£ļ░£ļÉśņ¢┤ņĢ╝ ĒĢĀ Ļ▓āņØ┤ļŗż. ĒŖ╣Ē׳ Ļ│Āņś©ņŚÉņä£ ļ│┤ļŗż ņĢłņĀĢņĀüņØĖ ļ¼┤ņŚ░ņåöļŹöņØś Ļ░£ļ░£ņØä ĒåĄĒĢśņŚ¼ ļ»ĖņäĖĻĄ¼ņĪ░ņØś ļ│ĆĒÖöņŚÉļÅä ļ¦īņĪ▒ĒĢĀ ļ¦īĒĢ£ ņŗĀļó░ņä▒ņØä ĒÖĢļ│┤ĒĢśĻĖ░ ņ£äĒĢ£ ļ¦ÄņØĆ ņŚ░ĻĄ¼Ļ░Ć ĒĢäņÜöĒĢ£ ņāüĒā£ļØ╝ ņāØĻ░üļÉ£ļŗż.








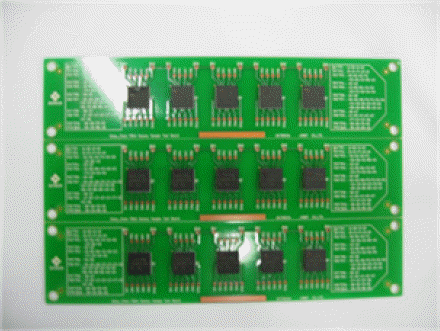
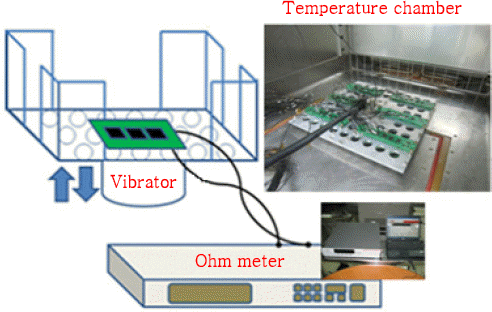


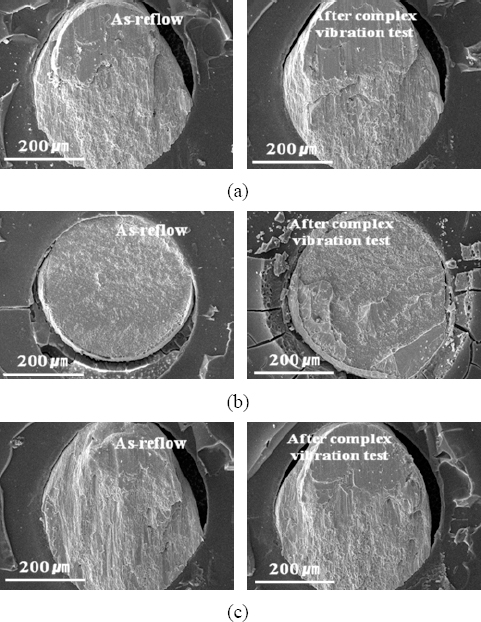

 PDF Links
PDF Links PubReader
PubReader ePub Link
ePub Link Full text via DOI
Full text via DOI Download Citation
Download Citation Print
Print



